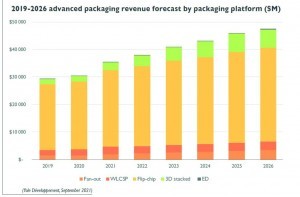 Abb. 1: Advanced Packaging Umsatzentwicklung in Mio. $, aufgeschlüsselt nach eingesetzter Plattform bis 2026Mit dem Aufkommen anspruchsvoller Anwendungsfelder und Technologietreiber – Big Data, Künstliche Intelligenz, 5G, High-Performance Computing (HPC), AR/VR/MR (Artificial/Virtual/Mixed Reality), Cloud/Edge Computing, IIoT (Industrial Internet of Things), selbstfahrende Fahrzeuge, Industrie 4.0 und Hyperscale-Datenzentren – sieht sich die Hableiterindustrie starken Herausforderungen bei der bedarfsgerechten Auslegung ihrer Komponenten gegenüber. Die neuen Anwendungen schaffen Nachfragepotenzial für Systeme und Subsysteme mit hoher Rechenleistung und hoher Bandbreite bei geringer Latenz und niedrigem Leistungsverbrauch. Hinzu kommt die wachsende Funktionalität der Systeme mit größerem Speicherplatz und der Unterstützung diverser Sensorklassen. Einfache Integration auf der Systemebene bei gleichzeitiger Kostenreduktion ist eine weitere Forderung der Anwender.
Abb. 1: Advanced Packaging Umsatzentwicklung in Mio. $, aufgeschlüsselt nach eingesetzter Plattform bis 2026Mit dem Aufkommen anspruchsvoller Anwendungsfelder und Technologietreiber – Big Data, Künstliche Intelligenz, 5G, High-Performance Computing (HPC), AR/VR/MR (Artificial/Virtual/Mixed Reality), Cloud/Edge Computing, IIoT (Industrial Internet of Things), selbstfahrende Fahrzeuge, Industrie 4.0 und Hyperscale-Datenzentren – sieht sich die Hableiterindustrie starken Herausforderungen bei der bedarfsgerechten Auslegung ihrer Komponenten gegenüber. Die neuen Anwendungen schaffen Nachfragepotenzial für Systeme und Subsysteme mit hoher Rechenleistung und hoher Bandbreite bei geringer Latenz und niedrigem Leistungsverbrauch. Hinzu kommt die wachsende Funktionalität der Systeme mit größerem Speicherplatz und der Unterstützung diverser Sensorklassen. Einfache Integration auf der Systemebene bei gleichzeitiger Kostenreduktion ist eine weitere Forderung der Anwender.
Die wichtigsten Technologien des Advanced Packaging sind: Chiplets für die heterogene Integration, WoW (Wafer on Wafer) für 3D Nand-Speicher, HBM (High Bandwidth Memory) mit 12 oder 16 Ebenen an Die-Stacking mit Pitch-Skalierung auf 35 µm, 3D-SoCs (System on Chip) mit Hybrid-Bonding (Logik/Logik und Speicher/Logik), Stacked 3D-ICs für Rechensysteme in Datenzentren und für High Performance Computing. Das führt zu großvolumigen Gehäusen (100 x 100 mm2), insbesondere für KI-Systeme, HPC und Datennetze. Und es bedingt innovative Packaging-Lösungen für mobile 5G-Millimeterwellensysteme, doppelseitig umformte (double-side molded) BGAs (ball grid arrays), Antennenmaterialien mit geringen dielektrischen Verlusten, AiP-Konfigurationen (antenna in package) und anderem mehr. Die Weiterentwicklung und Adoption von hoch dichtem Fan-out für all-side-molded WLCSP (Wafer-Level Chip-Scale Packaging) dürfte sich insbesondere für Mobilfunkgeräte und HPC beschleunigen, etwa beim Chip-last Fan-out mit RDL- (redistribution layer) Interposer.
Advanced Packaging Trends
 Abb. 2: Umsätze der OSATs im AP-Segment im Jahr 2020 aufgeschlüsselt nach WeltregionenIn ihrer aktuellen Studie ‚Status of the Advanced Packaging Industry 2021, Market & Technology Report – September 2021' befassen sich drei leitende Analysten (Santosh Kumar, Favier Shoo und Stefan Chitoraga) des französischen Marktforschers Yole Développement mit der industriellen Dynamik, den Technologietreibern und den künftigen Applikationen des Advanced Packaging, einem viel versprechenden Trend der Halbleiterfertigung. Sie schlüsseln die zu erwartenden Marktgelegenheiten, möglichen Hindernisse und Disruptionen der Entwicklung auf, und sie entwerfen Roadmaps der Frontend-Skalierung und der Funktionserweiterungen der Systeme über die nächsten fünf Jahre. Abschließend skizzieren sie die Positionen der dominanten Anbieter und Dienstleister (IDMs, OSATs, Foundries) und deren fluide Geschäftsmodelle.
Abb. 2: Umsätze der OSATs im AP-Segment im Jahr 2020 aufgeschlüsselt nach WeltregionenIn ihrer aktuellen Studie ‚Status of the Advanced Packaging Industry 2021, Market & Technology Report – September 2021' befassen sich drei leitende Analysten (Santosh Kumar, Favier Shoo und Stefan Chitoraga) des französischen Marktforschers Yole Développement mit der industriellen Dynamik, den Technologietreibern und den künftigen Applikationen des Advanced Packaging, einem viel versprechenden Trend der Halbleiterfertigung. Sie schlüsseln die zu erwartenden Marktgelegenheiten, möglichen Hindernisse und Disruptionen der Entwicklung auf, und sie entwerfen Roadmaps der Frontend-Skalierung und der Funktionserweiterungen der Systeme über die nächsten fünf Jahre. Abschließend skizzieren sie die Positionen der dominanten Anbieter und Dienstleister (IDMs, OSATs, Foundries) und deren fluide Geschäftsmodelle.
Der AP-Markt erreichte 2020 laut Yole weltweit ein Umsatzvolumen von 30 Mrd. $. Er dürfte mit mittleren Wachstumsraten von 8 % weiter wachsen und 2026 einen Wert von 47,5 Mrd. \( erreichen. Für das ,traditionelle' Packaging prognostiziert Yole in diesem Zeitraum ein mittleres Jahreswachstum von nur 4,4 % auf 50 Mrd. \). Beide Segmente zusammen genommen erreichen eine Wachstumsrate von 6 % auf 95,5 Mrd. $. Dabei dürfte sich der Anteil des AP-Segments bis 2026 auf etwa 50 % erhöhen. Heute dominieren, umgerechnet auf Waferstarts mit 300 mm Durchmesser, die traditionellen Chipgehäuse mit einem Marktanteil von 72 %. Die Profitmargen des AP-Segments erreichen etwa das Doppelte des traditionellen Packaging, was für die Hersteller recht attraktiv ist. Den größten Anteil in Bezug auf die eingesetzten AP-Technologien nehmen derzeit die Flip-Chips ein. Ihr Anteil, sagt Yole, dürfte bis 2026 auf 80 % des AP-Marktes steigen.
Eine weitere, in dynamischer Entwicklung begriffene Advanced-Packaging-Plattform sind die 3D/2.5D Chipstacking-Technologien und das Fan-out Konzept. Sie werden bis 2026 ein Jahreswachstum von 22 %, bzw. 16 % erreichen, da ihr Einsatz in zukünftigen Applikationen an Breite gewinnt. Das Fan-in Wafer Level Packaging (WLP) als direkter Chip Interconnect wird in den kommenden fünf Jahren mit mittleren Raten von 5 % wachsen. Bislang ist der WLCSP-Anteil am Gesamtmarkt mit 51 Mio. $ noch recht bescheiden. Doch er wird getrieben von Embedded-Applikationen in den Bereichen Infrastruktur, Automotive und Mobilfunk und dürfte mittlere Wachstumsraten von 22 % realisieren.
Insgesamt bringt der Yole-Report neben einer Übersicht über die aktuellen Markt- und Technologie-Entwicklungen auch eine Analyse der diversen weltweiten Lieferketten mit der Positionierung der Lieferanten und deren Expansionsstrategien nebst Abschätzung ihrer Waferkapazitäten und Gewinnaussichten. Hinzu kommen Forecasts für die in den unterschiedlichen Applikationen zu erwartenden Stückzahlen der AP-Plattformen im Zeitraum bis 2026 (Abb. 1).
Anbieter-Struktur von AP-Lösungen
Ebenso interessant ist die in der Studie genannte Abschätzung der Struktur der Anbieter von Advanced Packaging Lösungen. Das sind im Wesentlichen die OSATs (Outsourced Semiconductor Assembly and Test), aber auch die großen Foundries und sogar die traditionellen IDMs, die sich im High-end-Bereich des AP Chancen ausrechnen. Derzeit, so Yole, dominieren die OSATs mit einem Anteil von 70 % den AP-Markt, gemessen in der Zahl der Waferstarts (Abb. 2). Doch gerade im High-end (2.5D/3D Stacking, High-Density Fan-out etc.), halten die großen Foundries wie TSMC sowie IDMs (Integrated Device Manufacturer) wie Intel und Samsung substanzielle Marktanteile. Sie investieren gezielt in die AP-Technologien und arbeiten daran, das Packaging vom Substrat auf alternative Si-Wafer-basierte Plattformen zu verlagern.
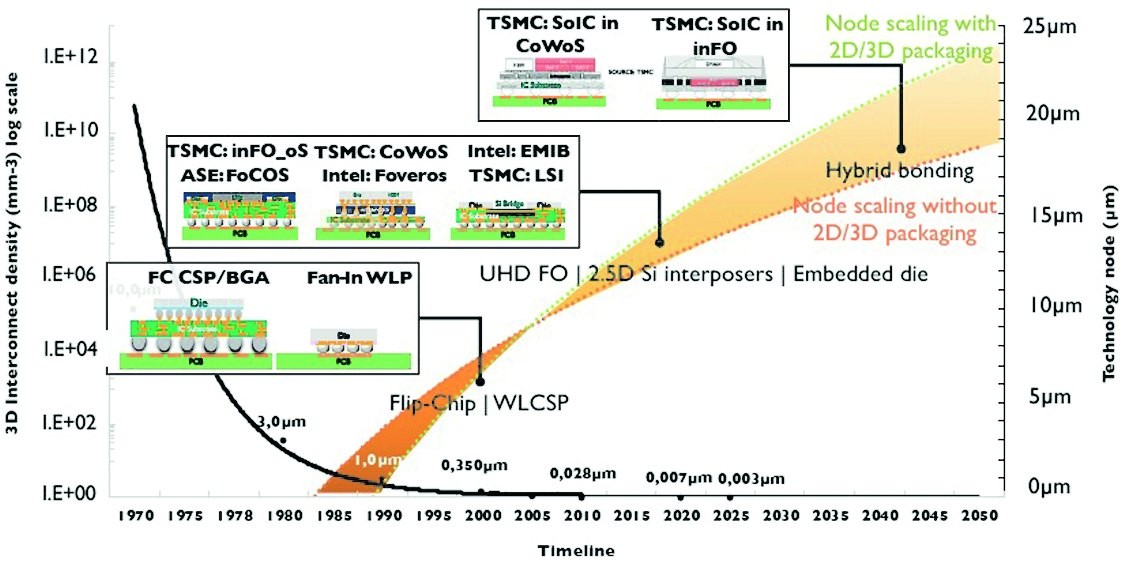 Abb 3: Roadmap der Packaging-Technologie-Entwicklung von 1970 bis 2050
Abb 3: Roadmap der Packaging-Technologie-Entwicklung von 1970 bis 2050
Wie Yole ermittelt hat, erzielte TSMC beispielsweise im letzten Jahr einen Umsatz von etwa 3,6 Mrd. \( im AP-Segment. Das Investitionsvolumen (CapEx) in 2021 beläuft sich auf 2,8 Mrd. \) für die Entwicklung von SoIC (small-outline integrated circuit), SoW (chip on wafer), InFO (Chip First) und CoWoS (Chip Last) -Plattformen und -Produktlinien. Bei Intel zielt das Investment auf diverse AP-Produktportfolios wie Foveros, EMIB und Co-EMIB im Rahmen der kürzlich angekündigten IDM-2.0 Strategie als Route zu neuen Führungspositionen in der Halbleiterindustrie im Bereich der Anwendungen für Datenzentren. Auch Samsung investiert aggressiv in die AP-Technologie, um sich gegenüber TSMC weiter zu profilieren. Eine Übersicht der historischen Entwicklung der Packaging-Technologien zeigt Abbildung 3.
Natürlich verstärken auch die OSATs ihre Anstrengungen in Richtung des Einsatzes innovativer AP-Technologien. Bei Yole schätzt man, das die OSATs ihre Kapital-Outlays bereits für das Jahr 2020 um bis zu 27 % erhöht haben, was zu ihrem guten Abschneiden trotz der negativen Auswirkungen der Covid-19 Pandemie beigetragen hat. Neben den OSATs und IDMs drängen jetzt auch andere Player aus dem Assembly-Business, wie Substrat- und PCB-Anbieter und EMS(electronic manufacturing service)- Betriebe, auf das Gebiet des Advanced Packaging. Das hat Implikationen für die traditionellen Lieferketten der Halbleiterherstellung, auf die Yole im genannten Report detailliert eingeht.





