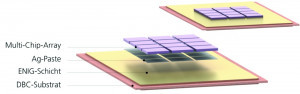 Multichip-Aufbau mit allen KomponentenTogether with the TU Chemnitz and the Japanese partner Shinko Electric Industries Co., Ltd. the Fhg ENAS has developed the new joining technology inductive bonding for microsystems. It was presented at the MEMS Sensing & Network System 2022 in Tokyo at the end of January. The process is revolutionary, especially for the production of power electronics units.
Multichip-Aufbau mit allen KomponentenTogether with the TU Chemnitz and the Japanese partner Shinko Electric Industries Co., Ltd. the Fhg ENAS has developed the new joining technology inductive bonding for microsystems. It was presented at the MEMS Sensing & Network System 2022 in Tokyo at the end of January. The process is revolutionary, especially for the production of power electronics units.
Induktives Fügen ist eine Technologie, die bisher vorwiegend nur für makroskopische Bauteile angewendet wird – Beispiele sind Stahlrohre oder Autotüren. Die gemeinsame Entwicklung vom Fraunhofer-Institut für Elektronische Nanosysteme ENAS in Chemnitz und seinen Partnern, der TU Chemnitz und der japanischen Firma Shinko, bringt das induktive Fügen erstmalig auch auf die Mikroebene. Für die mechanische Flächenkontaktierung von Chips auf DBC(direct bonded copper)-Substraten wurde der Bondprozess auf Basis von Sinterpasten mit Mikrosilberpartikeln entwickelt. Fügeprozesse von Siliziumchips auf einem DBC-Substrat wurden im Laufe der Entwicklung mit solchen Silbersinterpasten erfolgreich durchgeführt.
Bei diesem Verfahren können vor allem bei der Heterointegration von Chips und Komponenten verschiedenste Vorteile genutzt werden:
- Das induktive Verfahren ermöglicht ein sehr schnelles Aufheizen gezielter Strukturen zum Beispiel von Bondpads, die bei einer hohen lokalen Temperatur mit dem Bondpartner gefügt werden.
- Der Temperatureintrag erfolgt vor allem lokal in den Bereichen der Induktionsspulen, sodass die umliegenden Strukturen und Bauteile sowie das gesamte Substrat durch das sehr schnelle Aufheizen und Abkühlen der lokalen Strukturen deutlich geringer thermisch beeinflusst werden.
- Mit Hilfe von Induktionsspulen, die geometrisch an die Bondstrukturen angepasst sind, induziert ein hochfrequentes elektromagnetisches Feld Wirbelströme in das elektrisch leitfähige Silberpartikel-Pad. Erwärmungsraten von mehr als 100 K/s wurden damit erzeugt.
- Die gesamte Prozessdauer reduziert sich mit diesem Verfahren entscheidend, da die Zieltemperatur von 300 °C in nur fünf Sekunden erreicht wird.
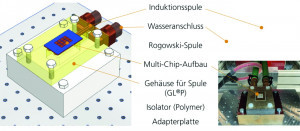 Aufbau des Sintermoduls mit den EinzelkomponentenIm Rahmen der Forschungsarbeiten wurde ein Testaufbau bestehend aus einer Prozesskammer mit einem Sintermodul, einer Druckplatte und einer Infrarotkamera zur Prozessüberwachung entwickelt. Im Sintermodul befindet sich eine wassergekühlte Induktionsspule in einem elektrisch isolierenden Umgebungsmaterial. Mittels Prozessüberwachung wurde der Spulenstrom und die Arbeitsfrequenz in Echtzeit aufgezeichnet.
Aufbau des Sintermoduls mit den EinzelkomponentenIm Rahmen der Forschungsarbeiten wurde ein Testaufbau bestehend aus einer Prozesskammer mit einem Sintermodul, einer Druckplatte und einer Infrarotkamera zur Prozessüberwachung entwickelt. Im Sintermodul befindet sich eine wassergekühlte Induktionsspule in einem elektrisch isolierenden Umgebungsmaterial. Mittels Prozessüberwachung wurde der Spulenstrom und die Arbeitsfrequenz in Echtzeit aufgezeichnet.
Vor allem für Hersteller von Baugruppen der Leistungselektronik ist dieses Verfahren revolutionär, da die Dauer von Fügeprozessen deutlich verringert und die thermische Beeinflussung aller Fügekomponenten reduziert wird. Die mechanische Kontaktierung durch Silbersinterpasten erlaubt es, dabei die hohe Abwärme der Bauteile schnell und gezielt über die gesinterten Strukturen abzuführen.
Der japanische Entwicklungspartner Shinko bietet den Prozess als industrialisiertes Verfahren an und entwickelt ihn gemeinsam mit den Projektpartnern TU Chemnitz und ENAS kontinuierlich weiter.
Auf der Fachmesse MEMS Sensing & Network Systems 2022, die vom 26. bis 28. Januar im Tokyo Big Sight Messe- und Veranstaltungskomplex stattfand, wurde das Verfahren am Gemeinschaftsstand der Tohoku Universität und FhG ENAS vorgestellt. Ein Paper zum induktiven Chipbonden kann unter folgendem E-Mail-Kontakt angefordert werden: Diese E-Mail-Adresse ist vor Spambots geschützt! Zur Anzeige muss JavaScript eingeschaltet sein! (Betreff: Paper inductive bonding).













