Estimados miembros, amigos y partes interesadas de IMAPS-Deutschland e. V.,
la sección nacional de la Sociedad Internacional de Microelectrónica y Embalaje en la República Federal de Alemania. Atrás queda un trimestre lleno de acontecimientos. Después de tres años de restricciones de diversa índole relacionadas con la pandemia, las actividades de la comunidad nacional, europea e internacional están volviendo en gran medida a la normalidad. En particular, las conferencias, como plataformas más importantes de intercambio de conocimientos y tecnología, pueden volver a celebrarse en persona.
Del 2 al 3 de febrero de 2023, nuestros colegas estadounidenses de San Diego invitaron al "Topical Workshop & Tabletop Exhibition on WIRE BONDING" y muchos interesados respondieron a esta convocatoria. Gracias en parte a nuestro miembro HESSE Mechatronics, los participantes pudieron conocer los últimos avances en tecnologías de wire bonding en las áreas de aplicación de producción de baterías para e-movilidad y energía sostenible, fabricación de semiconductores y envases microelectrónicos en diversas presentaciones, así como en el taller dirigido por Mike McKeown, e intercambiar ideas en sesiones de trabajo conjuntas.
El wire bonding sigue siendo el método predominante de conexión de chips, con una cuota de mercado superior al 85%, y ofrece ventajas extraordinarias sobre la tecnología flip-chip. Cada año se producen miles de millones de uniones por hilo. En instalaciones de gran volumen y bien controladas, las tasas de defectos se sitúan en un rango bajo de ppm. Por tanto, sigue siendo un método rentable y, sobre todo, extremadamente flexible de conexión de chips.
Tanto en la unión por bola como en la unión por cuña, el alambre entre la herramienta de unión y la almohadilla de unión o el sustrato se deforma masivamente, creando una unión soldada. Las variables dominantes que influyen en la deformación son la energía ultrasónica, la temperatura, la fuerza de unión y el tiempo de unión.
La energía ultrasónica es la principal variable del proceso de unión por hilo. Reduce las fuerzas necesarias y permite la deformación con una tensión significativamente menor sobre el alambre y los componentes que se van a unir, como el chip y el sustrato, de lo que sería necesario de otro modo. Los ultrasonidos de alta frecuencia proporcionan mayores velocidades de deformación y permiten una deformación más rápida y controlada, lo que es necesario para una unión precisa con altos rendimientos y alta productividad. Esto se aplica tanto a la unión por hilo fino, muy extendida, como a la unión por hilo grueso, cada vez más frecuente, como señaló Lee Levine en su tutorial.
Otras presentaciones interesantes destacaron los retos, pero también las variaciones de proceso y las soluciones para el pegado de alambres gruesos de cobre, el uso de nuevos materiales de pegado, los requisitos de alta fiabilidad y análisis de fallos, así como nuevas estrategias de prueba con retos de sistema y densidades de empaquetado cada vez mayores.
En resumen, un programa muy actual, que se completó con la presencia de una decena de expositores en la exposición paralela.
Casi aprovechando el contenido de la conferencia de San Diego, nuestros colegas franceses de Poitier organizaron del 8 al 9 de marzo de 2023 un taller sobre gestión térmica, que lamentablemente no contó con la asistencia que el tema merecía debido a la huelga simultánea de la administración pública y el sistema de transporte. Las presentaciones relacionadas con la investigación, la industria y la innovación sobre el tema de la refrigeración de circuitos integrados y paquetes, materiales avanzados, gestión térmica en toda la cadena de procesos, desde el material base a los componentes, materiales auxiliares y operativos hasta el producto acabado, habrían merecido sin duda más atención aquí.
¿Y qué pueden esperar nuestros miembros de nosotros, IMAPS Deutschland e. V.?
Tras una pausa de tres años, IMAPS Alemania retomó su tradición de ofrecer un seminario de primavera sobre un tema de actualidad en la tecnología de microsistemas el 23 de marzo de 2023. Este año, hemos utilizado diversas presentaciones para crear una base de debate sobre un tema de actualidad apremiante relacionado con la sostenibilidad en la producción electrónica: ¿Cómo podemos conseguir que la producción o las fases de producción individuales sean sostenibles y qué aspectos deben tenerse en cuenta?
Este tema será el centro de nuestro informe en el próximo número de PLUS. Esté atento.
Prototipo de producción de sistema en lámina con chips de silicio ultrafinos en Hahn-Schickard
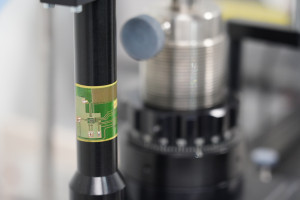 Fig. 1: System-in-Foil con chip de silicio ultrafino y contacto eléctrico con impresión por chorro de tinta (Fotos: Hahn-Schickard)Los microsistemas basados en láminas con chips de silicio ultrafinos integrados, más conocidos como System-in-Foil (SiF), pueden utilizarse allí donde los soportes de circuitos convencionales alcanzan sus límites (Fig. 1). Gracias a su escasa altura, estos sistemas pueden integrarse en estructuras de paredes delgadas. Esto permite, por ejemplo, el reequipamiento de sistemas de producción con sensores ("retrofit"), la funcionalización de elementos ligeros o la monitorización de baterías para ahorrar espacio. En el sector aeroespacial y en los vehículos eléctricos, el SiF puede contribuir al ahorro de peso. Además, su gran flexibilidad mecánica permite movimientos dinámicos, por lo que el SiF también puede instalarse en espacios de instalación curvados o realizarse para sensores próximos al cuerpo y en forma de wearables inteligentes para aplicaciones de tecnología médica.
Fig. 1: System-in-Foil con chip de silicio ultrafino y contacto eléctrico con impresión por chorro de tinta (Fotos: Hahn-Schickard)Los microsistemas basados en láminas con chips de silicio ultrafinos integrados, más conocidos como System-in-Foil (SiF), pueden utilizarse allí donde los soportes de circuitos convencionales alcanzan sus límites (Fig. 1). Gracias a su escasa altura, estos sistemas pueden integrarse en estructuras de paredes delgadas. Esto permite, por ejemplo, el reequipamiento de sistemas de producción con sensores ("retrofit"), la funcionalización de elementos ligeros o la monitorización de baterías para ahorrar espacio. En el sector aeroespacial y en los vehículos eléctricos, el SiF puede contribuir al ahorro de peso. Además, su gran flexibilidad mecánica permite movimientos dinámicos, por lo que el SiF también puede instalarse en espacios de instalación curvados o realizarse para sensores próximos al cuerpo y en forma de wearables inteligentes para aplicaciones de tecnología médica.
Para los chips de silicio ultrafinos, la parte posterior del chip se elimina por esmerilado. A partir de un grosor de 50 µm, el silicio cristalino se vuelve mecánicamente flexible y se puede doblar. Sin embargo, esto también dificulta la manipulación de los chips de silicio durante la cadena de procesos, desde el proceso pick & place hasta el montaje adhesivo. Una toma inadecuada de las virutas ultrafinas con una herramienta de succión puede provocar una fractura frágil. Además, los chips ultrafinos tienden a desarrollar tensiones termomecánicas debido a las estructuras de la superficie, que pueden provocar el abombamiento de todo el chip de silicio si no se fija constantemente durante el montaje.
El Hahn-Schickard-Institut für Mikroaufbautechnik ha desarrollado procesos manuales y automatizados para el ensamblaje de chips de silicio ultrafinos [1] mediante procesos adhesivos. Se consigue una distribución homogénea del adhesivo con un grosor de unos pocos micrómetros en los sustratos de película, de modo que el adhesivo no endurece el chip flexible. Tras el ensamblaje, los chips sensibles se incrustaron en una capa resistente a la soldadura flexible mediante un recubrimiento pulverizado para protegerlos. La capa de resistencia a la soldadura, de sólo 15-20 µm de grosor, se estructuró fotolitográficamente para abrir las superficies de contacto del chip de silicio. Como aquí se utilizó un proceso de exposición directa sin máscara basado en LED UV, los diseños para abrir las superficies de contacto y la posición de las aberturas podían variarse individualmente, por ejemplo para producir prototipos o para compensar cualquier torsión de los chips durante el montaje.
El contacto eléctrico de los chips de silicio ultrafinos se consigue mediante la impresión por chorro de tinta de tintas metálicas nanoparticuladas. Se investigaron tintas con nanopartículas de plata y oro(Fig. 2). Los diferentes disolventes de las tintas provocaron diferentes propiedades de humectación, que se manifestaron tanto como efecto de mancha de café como efecto Marangoni [2].
 Fig. 3: Sistema basado en láminas para la caracterización de la resistencia a la fatiga por flexiónAdemás dechips de silicio ultrafinos, en SiF también se suelen necesitar SMD como condensadores o resistencias. Para determinar la probabilidad de fallo de los componentes en contacto, se creó un banco de pruebas de flexión con el que se puede cargar SiF dinámicamente bajo radios de flexión definidos y con el que se pueden examinar diferentes capas de metalización y métodos de contacto.
Fig. 3: Sistema basado en láminas para la caracterización de la resistencia a la fatiga por flexiónAdemás dechips de silicio ultrafinos, en SiF también se suelen necesitar SMD como condensadores o resistencias. Para determinar la probabilidad de fallo de los componentes en contacto, se creó un banco de pruebas de flexión con el que se puede cargar SiF dinámicamente bajo radios de flexión definidos y con el que se pueden examinar diferentes capas de metalización y métodos de contacto.
Por ejemplo, se observó una tendencia hacia un mayor número de ciclos de flexión hasta el fallo con los SMD unidos conductivamente en comparación con los SMD soldados [3]. Por otro lado, el factor de forma del SMD mostró una influencia insignificante.
Bibliografía:
1. Janek, F.; Saller, E.; Müller, E.; Meißner, T.; Weser, S.; Barth, M.; Eberhardt, W.; Zimmermann, A.: Feasibility Study of an Automated Assembly Process for Ultrathin Chips (Estudio de viabilidad de un proceso de montaje automatizado para chips ultrafinos), Micromachines, 11, 2020, 654, doi:10.3390/mi11070654
2. Janek, F.; Eichhorn, N.; Weser, S.; Gläser, K.; Eberhardt, W.; Zimmermann, A.: Embedding of Ultrathin Chips in Highly Flexible, Photosensitive Solder Mask Resist, Micromachines, 12, 2021, 856, doi:10.3390/mi12080856
3. Saleh, R.; Schütt, S.; Barth, M.; Lang, T.; Eberhardt, W.; Zimmermann, A.: Assembly of Surface-Mounted Devices on Flexible Substrates by Isotropic Conductive Adhesive and Solder and Lifetime Characterisation, Micromachines, 13, 2022, doi:10.3390/mi13081240
Calendario de actos
|
Lugar |
Periodo |
Nombre |
Organizador |
|
Albuquerque |
18 - 20 abr 2023 |
3 en 1: CICMT+ HITEC+ PowerPack 2023 |
IMAPS/ACerS |
|
Oslo |
12 - 14 Jun 2023 |
NordPac 2023 |
IMAPS Nórdico |
|
Cambridge |
11 - 14 Sep 2023 |
EMPC 2023 |
IMAPS REINO UNIDO |
|
San Diego |
02 - 05 oct 2023 |
56º Simposio Internacional de Microelectrónica |
IMAPS EE.UU. |
|
Munich, Alemania |
19 / 20 oct 2023 |
Conferencia de otoño de IMAPS Alemania |
IMAPS DE |
|
Múnich, Alemania |
14 - 17 Nov 2023 |
SEMICON EUROPA |
SEMI Europa |
Este calendario está sujeto a cambios. Consulte la información y las notas de los organizadores en las respectivas páginas web.
IMAPS Alemania - Su asociación para la tecnología de embalaje e interconexión
IMAPS Alemania, parte de la Sociedad Internacional de Microelectrónica y Embalaje (IMAPS), ha sido el foro en Alemania para todos aquellos involucrados en la microelectrónica y la tecnología de embalaje desde 1973. Con casi 300 miembros, perseguimos esencialmente tres objetivos importantes:
- conectamos la ciencia y la práctica
- garantizamos el intercambio de información entre nuestros miembros y
- representamos el punto de vista de nuestros miembros en comités internacionales.
Pie de imprenta
IMAPS Alemania e. V.
Kleingrötzing 1, D-84494 Neumarkt-St. Veit
1er Presidente: Prof. Dr. Martin Schneider-Ramelow, Director del Instituto Fraunhofer de Fiabilidad y Microintegración (IZM),
Tesorero
(para cuestiones sobre afiliación y contribuciones):
Ernst G. M. Eggelaar,
Encontrará información detallada de contacto de los miembros de la Junta Directiva en www.imaps.de
(Junta Directiva)
Contacto:
Florian Janek
Sociedad Hahn-Schickard de Investigación Aplicada e. V.
Correo electrónico