La ECTC 2025 celebrada en Dallas, Texas (EE. UU.) a finales de mayo situó a los sustratos avanzados como la clave para el escalado de la IA y lideró el debate sobre el futuro de los sistemas de soporte para la electrónica de alto rendimiento.
En la conferencia más importante del mundo sobre tecnologías de envasado, que tuvo lugar del 27 al 30 de mayo de 2025 en el Gaylord Texan Resort & Convention Center de Dallas, los sustratos avanzados ocuparon un lugar central en el diálogo del sector. Con más de 2.500 asistentes, una exposición totalmente llena con 138 stands y once paneles especiales, quedó claro que la elección del sustrato se ha convertido en el marcapasos de la próxima generación de sistemas altamente integrados [1].
Marcando el rumbo tecnológico de los sustratos de vidrio y RDL
El evento especial "Glass Core vs. RDL Interposer Substrates: Ready for Prime-Time?", que se llenó con más de 350 asistentes, fue el centro de interés [1, 2]. Expertos de Samsung, Intel, TSMC, AMD, FICT, Toppan, Zeiss y Yield Engineering Systems arrojaron luz sobre las diferentes líneas de desarrollo de los dos conceptos de sustrato dominantes [1, 2].
Mientras que los interpositores basados en RDL ya se fabrican en serie y han demostrado su eficacia en inferencias de inteligencia artificial, conmutadores de red y sistemas periféricos, instituciones de investigación y agentes industriales como Imec, Fraunhofer IZM y Toppan están impulsando la transición a los sustratos con núcleo de vidrio [2, 5]. Parámetros como la estabilidad dimensional a altas temperaturas, las bajas pérdidas eléctricas, las propiedades de alabeo definidas y la creciente demanda de sustratos planares para ópticas coempaquetadas y arquitecturas de chiplets son factores decisivos aquí [1]. Samsung presentó avances en la integración de vías pasantes de vidrio (TGV) estructuradas por láser en núcleos de vidrio de 800 µm de grosor con ocho capas y 80 × 80 mm de longitud de borde [1]. Este año se está validando un encapsulado de 105 × 105 mm con un grosor de 840 µm, que se trasladará a la producción en serie a finales de 2027. Intel presentó su tecnología TGV con una relación de aspecto de 1:20 sobre vidrio, complementada con un llamamiento a establecer un ecosistema sólido para los paquetes de vidrio [1]. Toppan y FICT presentaron soluciones para la reducción de tensiones y el desacoplamiento termomecánico en la pila [1]. TSMC hizo hincapié en su elevada estabilidad de rendimiento para los paquetes RDL de hasta once capas y en la escalabilidad de su pila CoWoS-R, tanto para la informática de alto rendimiento como para los dispositivos periféricos [1]. AMD también confirmó la idoneidad de los paneles de vidrio para soluciones portadoras de gran superficie y baja distorsión [1].
El vidrio gana profundidad funcional
Paralelamente al debate del panel, Imec dio un impulso central con la demostración de una plataforma intercaladora de RF de 300 mm sobre silicio [5]. La combinación de CMOS y chiplets III/V en una portadora con una pérdida de inserción de sólo 0,73 dB/mm a una frecuencia de hasta 325 GHz está dirigida a aplicaciones de radio para centros de datos, transceptores ópticos o de corto alcance en sub-THz [5]. La plataforma utiliza BEOL de Cu Damascene para las redes de líneas digitales, complementadas con trayectos de ondas milimétricas sobre polímero de RF, e integra componentes pasivos directamente en el sustrato [5]. La estructura permite un paso de flip-chip de 40 µm y se ampliará a 20 µm en una próxima etapa [5].
Además del desarrollo de sustratos de vidrio para la integración de radiofrecuencia, varias contribuciones demostraron que la propia mecánica del vidrio puede optimizarse: con ingeniería de tensión específica, ajustes litográficos y capas de redistribución trasera (RDL), no sólo pueden adaptarse los perfiles CTE, sino que también pueden abordarse retos de empaquetado como la alineación de las matrices, el alabeo o el acoplamiento entre capas. En definitiva, está surgiendo una clase de material que evoluciona cada vez más de soporte óptico a intercalador funcional.
Gestión térmica y vías de corriente en la cara posterior
Otro aspecto destacado del ECTC fue la sesión sobre suministro de corriente por la cara posterior (BPD), en la que IBM, imec, Georgia Tech y Purdue presentaron nuevos conceptos para la integración de microcanales, TSV y disipadores térmicos integrados [1]. Los principales retos eran la resistencia térmica en arquitecturas tridimensionales y el comportamiento de mapas térmicos complejos a distintas profundidades de empaquetado [1]. El vidrio se mencionó en varias ocasiones como sustrato adecuado para el soporte base termomecánico, especialmente en lo que respecta a su estructurabilidad de alta precisión, las geometrías planas de las vías y la posibilidad de combinarlo con microdiscos de cobre o estructuras de refrigeración basadas en diamante [1].
 El equipo de Koh Young en el ECTC (de izquierda a derecha): JD Shin, Brent Fischthal, Allen Phung y Joel Scutchfield
El equipo de Koh Young en el ECTC (de izquierda a derecha): JD Shin, Brent Fischthal, Allen Phung y Joel Scutchfield
Koh Young: la metrología en línea como clave de la calidad del sustrato
Con True3D y la clasificación de defectos asistida por IA, la empresa Koh Young abordó el problema del control del alabeo y la detección de defectos en la estructura multicapa de los sustratos de vidrio [3]. Los sistemas presentados permiten detectar en línea y sin fisuras la planitud, las microfisuras, el volumen de soldadura o el relleno de las vías, parámetros importantes para garantizar un alto índice de rendimiento en el envasado avanzado con bajas tolerancias de defectos [3]. Koh Young no sólo actuó como patrocinador exclusivo de la velada de gala, sino que también presentó en su propio stand soluciones específicas de bucle cerrado para el control de procesos y la validación de sustratos [3].
 Koh Young presentó soluciones de inspección para la fabricación de semiconductores en el ECTC 2025 de Texas
Koh Young presentó soluciones de inspección para la fabricación de semiconductores en el ECTC 2025 de Texas
El vidrio se consolida como material de interposición y sustrato
El ECTC 2025 de Texas documentó de forma impresionante que el debate sobre los materiales de sustrato ya no es académico. Las hojas de ruta de los principales fabricantes de semiconductores y envases muestran que el vidrio se impondrá cada vez más como material de interposición y sustrato en los próximos años, inicialmente en el ámbito de la óptica en coenvasado y, más adelante, también en los sectores de señal mixta y RF [1]. Ya se ha iniciado el escalado industrial, se han instalado las primeras líneas piloto y se están cualificando los primeros módulos. El RDL moldeado sigue siendo un estándar fiable para muchas aplicaciones, pero está alcanzando cada vez más sus límites en cuanto a densidad de capas, paso y acoplamiento térmico [2]. El futuro pertenece a la combinación de ambos - vidrio con estructura RDL - donde el envasado no es sólo una conexión, sino una plataforma de sistema.
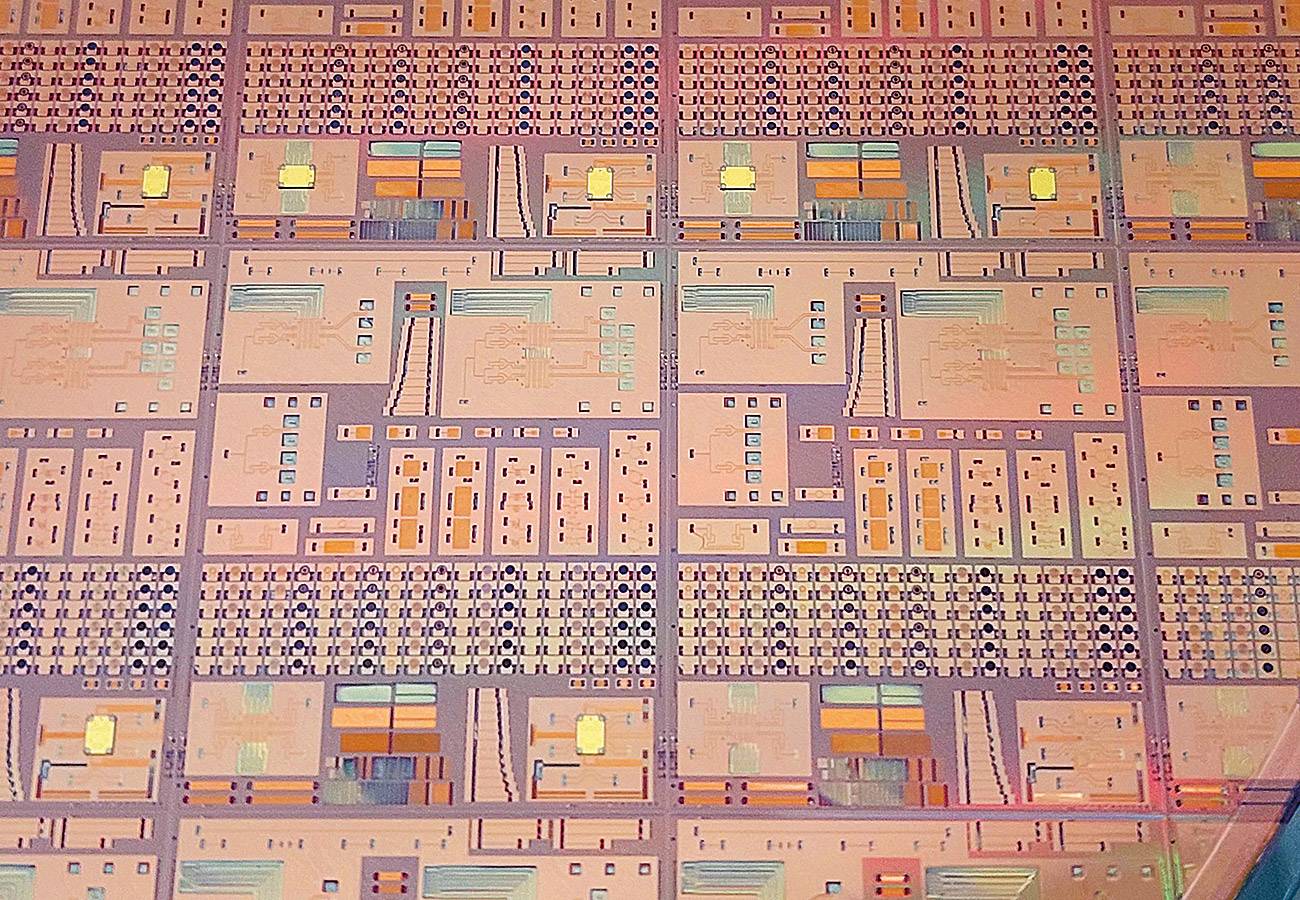 Plataforma de interposición de silicio RF de 300 mm de imec para la integración heterogénea basada en chiplets
Plataforma de interposición de silicio RF de 300 mm de imec para la integración heterogénea basada en chiplets
Referencias
[1] www.pcbdirectory.com/news/special-session-at-ieee-ectc-2025-explores-future-of-glass-core-and-rdl-interposer-substrates-technologies (acceso: 29/07/2025).
[2] timestech.in/glass-core-vs-rdl-interposer-substrates-ready-for-prime-time/ (acceso: 29/07/2025).
[3] iconnect007.com/article/145219/koh-young-invites-you-to-the-2025-ieee-electronic-components-and-technology-conference/145216/smt (consultado: 29/07/2025).
[4] www.eletimes.com/a-record-year-for-the-75th-annual-ieee-electronic-components-and-technology-conference-ectc (Recuperado: 29/07/2025).
[5] electronics360.globalspec.com/article/22381/ectc-2025-imec-demo-s-300-mm-rf-silicon-interposer-platform (Abruf: 29.07.2025).
Información
El próximo ECTC tendrá lugar del 26 al 29 de mayo de 2026 en el JW Marriott Grande Lakes, Orlando (EE.UU.). Ya se pueden enviar los resúmenes de las ponencias. La convocatoria de ponencias finaliza el 12 de diciembre de 2025.





