Cambio en el Consejo de IMAPS Deutschland e.V.
 Desde octubre de 2024, Alexander Hensel, M.Sc., refuerza el Consejo de IMAPS Deutschland e.V. en el área de relaciones públicas. Tras estudiar ingeniería, trabajó durante siete años en la Cátedra de Automatización de la Fabricación y Sistemas de Producción (FAPS) de la Universidad de Erlangen-Nuremberg, donde realizó investigaciones en el campo de los procesos de recubrimiento térmico para aplicaciones de electrónica de potencia. También dirigió el departamento de investigación sobre producción electrónica, centrándose en los procesos basados en datos y la digitalización en la producción SMT y THT, la tecnología de montaje y conexión en la electrónica de potencia y la fabricación aditiva en la producción electrónica.
Desde octubre de 2024, Alexander Hensel, M.Sc., refuerza el Consejo de IMAPS Deutschland e.V. en el área de relaciones públicas. Tras estudiar ingeniería, trabajó durante siete años en la Cátedra de Automatización de la Fabricación y Sistemas de Producción (FAPS) de la Universidad de Erlangen-Nuremberg, donde realizó investigaciones en el campo de los procesos de recubrimiento térmico para aplicaciones de electrónica de potencia. También dirigió el departamento de investigación sobre producción electrónica, centrándose en los procesos basados en datos y la digitalización en la producción SMT y THT, la tecnología de montaje y conexión en la electrónica de potencia y la fabricación aditiva en la producción electrónica.
Como tecnólogo de producción, actualmente es responsable de los procesos de producción de módulos planos en Siemens AG en Erlangen.
Proyecto de investigación FlaMe (FKZ: 03EN4008F)
Los sustratos metalocerámicos (MCS) son componentes importantes de los módulos de electrónica de potencia y permiten una larga vida útil con una elevada capacidad de transporte de corriente. Sin embargo, debido a los procesos de fabricación generalizados de soldadura metálica activa (AMB) y unión directa de cobre (DCB), la metalización de los MCS se limita a la metalización plana y, por tanto, ofrece un potencial de optimización para la disipación de calor basada en las necesidades directamente debajo de los componentes semiconductores que generan calor.
 Como parte del proyecto de investigación FlaMe (FKZ: 03EN4008F), los refuerzos de cobre generados de forma aditiva -mediante unión de lecho de polvo basada en láser (PBF-LB/M)- se construyeron selectivamente sobre metalizaciones DCB y se caracterizaron para su uso en electrónica de potencia. La estructura general de los módulos de potencia considerados para la investigación del concepto se basa en la serie 3RF2 de 2 fases de relés de estado sólido Siemens Sirius. En simulaciones térmicas, los chips con un refuerzo de cobre espacialmente limitado de 0,5 mm sobre la metalización superior DCB de 0,3 mm de espesor inicial mostraron una temperatura máxima de 81°C con cargas pulsadas de 3 segundos seguidas de una pausa de 3 segundos, que era 26 K inferior a la temperatura máxima de la misma estructura sin refuerzo espacialmente limitado. El efecto se confirmó posteriormente en el laboratorio, ya que la temperatura máxima de la superficie de la viruta medida por termografía a 81 °C era 19 K inferior a la de la estructura comparable sin amplificación. Un aspecto clave que explica las diferentes temperaturas absolutas entre la simulación y la validación es la aparición de inclusiones de gas en la capa de soldadura, ya que la soldadura no se realizó en atmósfera de vacío. Para analizar la influencia del concepto en la vida útil, se realizaron pruebas comparativas de cambio de carga entre módulos no modificados y módulos modificados. Se comprobó que el aumento de la metalización del cobre bajo el chip a una oscilación de temperatura de 110 K (40 °C a 150 °C) provocaba un aumento de la pérdida de potencia de 92 W a 109 W de media. Por otro lado, la vida útil se redujo de una media de 26.006 ciclos (n=2) a 9.531 ciclos (n=3) al reforzar la metalización del chip, lo que se debe al aumento del coeficiente de expansión termomecánica del cobre como consecuencia del refuerzo.
Como parte del proyecto de investigación FlaMe (FKZ: 03EN4008F), los refuerzos de cobre generados de forma aditiva -mediante unión de lecho de polvo basada en láser (PBF-LB/M)- se construyeron selectivamente sobre metalizaciones DCB y se caracterizaron para su uso en electrónica de potencia. La estructura general de los módulos de potencia considerados para la investigación del concepto se basa en la serie 3RF2 de 2 fases de relés de estado sólido Siemens Sirius. En simulaciones térmicas, los chips con un refuerzo de cobre espacialmente limitado de 0,5 mm sobre la metalización superior DCB de 0,3 mm de espesor inicial mostraron una temperatura máxima de 81°C con cargas pulsadas de 3 segundos seguidas de una pausa de 3 segundos, que era 26 K inferior a la temperatura máxima de la misma estructura sin refuerzo espacialmente limitado. El efecto se confirmó posteriormente en el laboratorio, ya que la temperatura máxima de la superficie de la viruta medida por termografía a 81 °C era 19 K inferior a la de la estructura comparable sin amplificación. Un aspecto clave que explica las diferentes temperaturas absolutas entre la simulación y la validación es la aparición de inclusiones de gas en la capa de soldadura, ya que la soldadura no se realizó en atmósfera de vacío. Para analizar la influencia del concepto en la vida útil, se realizaron pruebas comparativas de cambio de carga entre módulos no modificados y módulos modificados. Se comprobó que el aumento de la metalización del cobre bajo el chip a una oscilación de temperatura de 110 K (40 °C a 150 °C) provocaba un aumento de la pérdida de potencia de 92 W a 109 W de media. Por otro lado, la vida útil se redujo de una media de 26.006 ciclos (n=2) a 9.531 ciclos (n=3) al reforzar la metalización del chip, lo que se debe al aumento del coeficiente de expansión termomecánica del cobre como consecuencia del refuerzo.
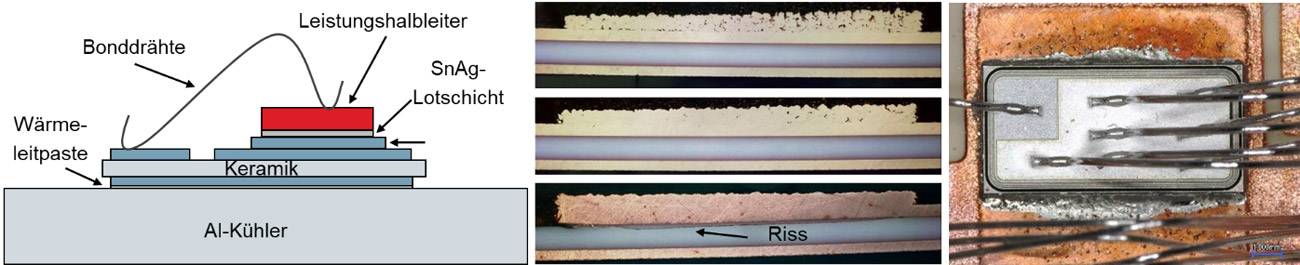 Concepto de configuración para la funcionalización cercana al chip de la metalización DCB de la cara superior (izquierda), estudio de parámetros para construir una estructura densa de cobre sin dañar la cerámica (centro) y configuración de laboratorio del concepto para la caracterización térmica y las pruebas de ciclos de carga (derecha).
Concepto de configuración para la funcionalización cercana al chip de la metalización DCB de la cara superior (izquierda), estudio de parámetros para construir una estructura densa de cobre sin dañar la cerámica (centro) y configuración de laboratorio del concepto para la caracterización térmica y las pruebas de ciclos de carga (derecha).
Calendario de actos
| Lugar | Periodo | Nombre del acto | Organizador |
| Copenhague, Dinamarca | 10-12 de junio de 2025 | NordPac | IMAPS Nórdico |
| Grenoble, Francia | 16-18 septiembre 2025 | IMAPS Europa EMPC 2025 | IMAPS Francia |
| San Diego, EE.UU. | 29 sept - 2 oct 2025 | Simposio IMAPS 2025 | IMAPS EE.UU. |
| Múnich, Alemania | 16-17 oct. 2025 | Conferencia de otoño | IMAPS DE |
| Phoenix, EE.UU. | 2 - 5 marzo 2026 | Conferencia sobre embalaje de dispositivos | IMAPS EE.UU. |
IMAPS Alemania - Su asociación para la tecnología de embalaje e interconexión
IMAPS Alemania, parte de la Sociedad Internacional de Microelectrónica y Embalaje (IMAPS), ha sido el foro en Alemania para todos los implicados en la microelectrónica y la tecnología de embalaje desde 1973. Con casi 250 miembros, perseguimos esencialmente tres objetivos importantes:
- conectamos la ciencia y la práctica
- garantizamos el intercambio de información entre nuestros miembros y
- representamos el punto de vista de nuestros miembros en comités internacionales.
Pie de imprenta
IMAPS Alemania e. V.
Kleingrötzing 1, D-84494 Neumarkt-St. Veit
1er Presidente:
Prof. Dr. Martin Schneider-Ramelow
Director del Instituto Fraunhofer de Fiabilidad y Microintegración (IZM)
Tesorero
(para cuestiones sobre afiliación y contribuciones):
Ernst G. M. Eggelaar,
Encontrará información de contacto detallada sobre los miembros de la Junta Directiva en www.imaps.de
(Junta Directiva)





