Veränderung im Vorstand des IMAPS Deutschland e.V.
 Seit Oktober 2024 verstärkt Alexander Hensel, M.Sc., den Vorstand der IMAPS Deutschland e.V. im Bereich der Öffentlichkeitsarbeit. Nach dem Studium der Ingenieurwissenschaften arbeitete er sieben Jahre am Lehrstuhl für Fertigungsautomatisierung und Produktionssystematik (FAPS) an der Universität Erlangen-Nürnberg und forschte dort im Bereich thermischer Beschichtungsverfahren für leistungselektronische Anwendungen. Weiterhin leitete er den Forschungsbereich Elektronikproduktion mit den Schwerpunkten datengetriebene Verfahren und Digitalisierung in der SMT- und THT-Fertigung, Aufbau- und Verbindungstechnik in der Leistungselektronik sowie additive Fertigung in der Elektronikproduktion.
Seit Oktober 2024 verstärkt Alexander Hensel, M.Sc., den Vorstand der IMAPS Deutschland e.V. im Bereich der Öffentlichkeitsarbeit. Nach dem Studium der Ingenieurwissenschaften arbeitete er sieben Jahre am Lehrstuhl für Fertigungsautomatisierung und Produktionssystematik (FAPS) an der Universität Erlangen-Nürnberg und forschte dort im Bereich thermischer Beschichtungsverfahren für leistungselektronische Anwendungen. Weiterhin leitete er den Forschungsbereich Elektronikproduktion mit den Schwerpunkten datengetriebene Verfahren und Digitalisierung in der SMT- und THT-Fertigung, Aufbau- und Verbindungstechnik in der Leistungselektronik sowie additive Fertigung in der Elektronikproduktion.
Als Fertigungstechnologe verantwortet er derzeit bei der Siemens AG in Erlangen Prozesse der Flachbaugruppenfertigung.
Forschungsprojekt FlaMe (FKZ: 03EN4008F)
Metall-Keramik-Substrate (MKS) sind wichtige Komponenten in leistungselektronischen Modulen und ermöglichen hohe Lebensdauern bei gleichzeitig hoher Stromtragfähigkeit. Die Metallisierungen von MKS sind infolge der verbreiteten Herstellungsverfahren Active Metal Brazing (AMB) und Direct Copper Bonding (DCB) allerdings auf planare Metallsierungen limitiert und bieten damit Optimierungspotenzial für eine bedarfgerechte Entwärmung direkt unter den wärmeerzeugenden Halbleiterbauelementen.
 Im Rahmen des Forschungsprojektes FlaMe (FKZ: 03EN4008F) wurden additiv – mittels laserbasiertem Pulverbettschweißen (eng. PBF-LB/M) – generierte Kupferverstärkungen selektiv auf DCB-Metallisierungen aufgebaut und für den Einsatz in der Leistungselektronik charakterisiert. Der allgemeine Aufbau der betracheteten Leistungsmodule zur Erforschung des Konzeptes ist an die 2-phasige 3RF2 Baureihe der Siemens Sirius Halbleiterrelais angelehnt. In thermischen Simulationen wiesen Chips mit einer räumlich begrenzten Kupferverstärkung von 0,5 mm auf der initial 0,3 mm starken DCB-Oberseitenmetallisierung bei pulsförmigen Belastungen von 3 Sekunden mit anschließend 3 Sekunden Pause eine Maximaltemperatur von 81°C auf, welche 26 K geringer als die Maximaltemperatur des gleichen Aufbaus ohne räumlich begrenzte Verstärkung ausfiel. Der Effekt konnte anschließend im Labor bestätigt werden, wobei die mittels Thermografie gemessene Maximaltemperatur der Chipoberfläche mit 81 °C um 19 K geringer als der vergleichbare Aufbau ohne Verstärkung ausfiel. Ein wesentlicher Aspekt, der die unterschiedlichen absoluten Temperaturen zwischen Simulation und Validierung erklärt, ist das Auftreten von Gaseinschlüssen in der Lotschicht, da nicht unter Vakuumatmosphäre gelötet wurde. Um den Einfluss des Konzeptes auf die Lebensdauer zu analysieren, wurden vergleichende Lastwechseltests zwischen unmodifizierten Modulen und modifizierten Modulen durchgeführt. Dabei zeigte sich, dass die Verstärkung der Kupfermetallisierung unter dem Chip bei einem Temperaturhub von 110 K (40 °C auf 150 °C) zu einer Steigerung der Verlustleistung von 92 W auf 109 W im Mittel führt. Im Gegenzug sank die Lebensdauer durch die Verstärkung der Chipmetallisierung von im Mittel 26.006 Zyklen (n=2) auf 9.531 Zyklen (n=3), was auf den erhöhten thermomechanischen Ausdehnungskoeffizienten des Kupfers infolge der Verstärkung zurückzuführen ist.
Im Rahmen des Forschungsprojektes FlaMe (FKZ: 03EN4008F) wurden additiv – mittels laserbasiertem Pulverbettschweißen (eng. PBF-LB/M) – generierte Kupferverstärkungen selektiv auf DCB-Metallisierungen aufgebaut und für den Einsatz in der Leistungselektronik charakterisiert. Der allgemeine Aufbau der betracheteten Leistungsmodule zur Erforschung des Konzeptes ist an die 2-phasige 3RF2 Baureihe der Siemens Sirius Halbleiterrelais angelehnt. In thermischen Simulationen wiesen Chips mit einer räumlich begrenzten Kupferverstärkung von 0,5 mm auf der initial 0,3 mm starken DCB-Oberseitenmetallisierung bei pulsförmigen Belastungen von 3 Sekunden mit anschließend 3 Sekunden Pause eine Maximaltemperatur von 81°C auf, welche 26 K geringer als die Maximaltemperatur des gleichen Aufbaus ohne räumlich begrenzte Verstärkung ausfiel. Der Effekt konnte anschließend im Labor bestätigt werden, wobei die mittels Thermografie gemessene Maximaltemperatur der Chipoberfläche mit 81 °C um 19 K geringer als der vergleichbare Aufbau ohne Verstärkung ausfiel. Ein wesentlicher Aspekt, der die unterschiedlichen absoluten Temperaturen zwischen Simulation und Validierung erklärt, ist das Auftreten von Gaseinschlüssen in der Lotschicht, da nicht unter Vakuumatmosphäre gelötet wurde. Um den Einfluss des Konzeptes auf die Lebensdauer zu analysieren, wurden vergleichende Lastwechseltests zwischen unmodifizierten Modulen und modifizierten Modulen durchgeführt. Dabei zeigte sich, dass die Verstärkung der Kupfermetallisierung unter dem Chip bei einem Temperaturhub von 110 K (40 °C auf 150 °C) zu einer Steigerung der Verlustleistung von 92 W auf 109 W im Mittel führt. Im Gegenzug sank die Lebensdauer durch die Verstärkung der Chipmetallisierung von im Mittel 26.006 Zyklen (n=2) auf 9.531 Zyklen (n=3), was auf den erhöhten thermomechanischen Ausdehnungskoeffizienten des Kupfers infolge der Verstärkung zurückzuführen ist.
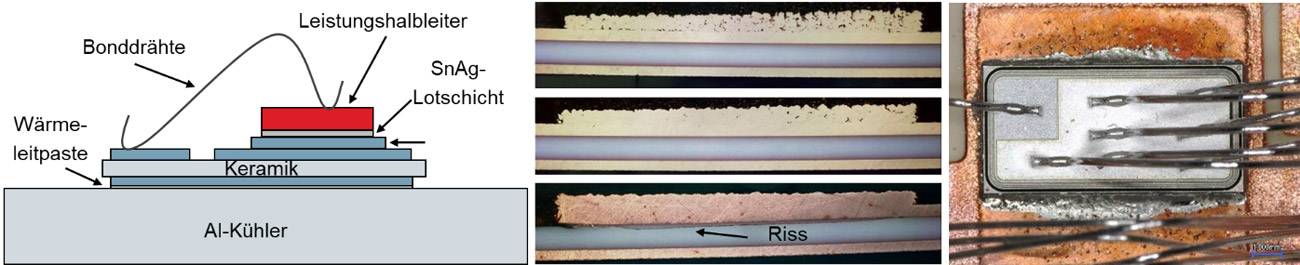 Aufbaukonzept zur chipnahen Funktionalisierung der oberseitigen DCB-Metallisierung (links), Parameterstudie zum Aufbau einer dichten Kupferstruktur ohne Schädigung der Keramik (Mitte) und Laboraufbau des Konzeptes zur thermischen Charakterisierung und für Lastwechseltests (rechts)
Aufbaukonzept zur chipnahen Funktionalisierung der oberseitigen DCB-Metallisierung (links), Parameterstudie zum Aufbau einer dichten Kupferstruktur ohne Schädigung der Keramik (Mitte) und Laboraufbau des Konzeptes zur thermischen Charakterisierung und für Lastwechseltests (rechts)
Veranstaltungskalender
| Ort | Zeitraum | Name | Veranstalter |
| Kopenhagen, Dänemark | 10.-12. Juni 2025 | NordPac | IMAPS Nordic |
| Grenoble, Frankreich | 16.-18. Sept. 2025 | IMAPS Europe EMPC 2025 | IMAPS France |
| San Diego, USA | 29. Sept.-2. Okt. 2025 | IMAPS Symposium 2025 | IMAPS USA |
| München | 16.- 17. Okt. 2025 | Herbstkonferenz | IMAPS DE |
| Phoenix, USA | 2.- 5. März 2026 | Device Packaging Conference | IMAPS USA |
IMAPS Deutschland – Ihre Vereinigung für Aufbau- und Verbindungstechnik
IMAPS Deutschland, Teil der „International Microelectronics and Packaging Society“ (IMAPS), stellt seit 1973 in Deutschland das Forum für alle dar, die sich mit Mikroelektronik und Aufbau- und Verbindungstechnik beschäftigen. Mit fast 250 Mitgliedern verfolgen wir im Wesentlichen drei wichtige Ziele:
- wir verbinden Wissenschaft und Praxis
- wir sorgen für den Informationsaustausch unter unseren Mitgliedern und
- wir vertreten den Standpunkt unserer Mitglieder in internationalen Gremien.
Impressum
IMAPS Deutschland e. V.
Kleingrötzing 1, D-84494 Neumarkt-St. Veit
1. Vorsitzender:
Prof. Dr.-Ing. Martin Schneider-Ramelow
Institutsleiter Fraunhofer-Institut für Zuverlässigkeit und Mikrointegration (IZM)
Schatzmeister
(bei Fragen zu Mitgliedschaft und Beitrag):
Ernst G. M. Eggelaar,
Ausführliche Kontaktinformationen zu den Vorstandsmitgliedern finden Sie unter www.imaps.de
(Vorstand)


