Silicium und Glas haben ähnliche thermische Ausdehnungskoeffizienten. Bei Substratmaterialien führen Temperaturwechsel im Betrieb sowie in der Herstellung zu Ausdehnungen und Schrumpfungen, die bei den Glaskernsubstraten zu deutlich weniger Stress führen. Entsprechend enthusiastisch werden ihre Entwicklung und ihr Markterfolg beobachtet.
Silicon and glass have similar coefficients of thermal expansion. With substrate materials, temperature changes during operation and production lead to expansion and shrinkage, which results in significantly less stress with glass-core substrates. Their development and market success are being watched with corresponding enthusiasm.
Aktuell kommen überwiegend organische Substrate als Trägermaterialien für Halbleiter-Dies zum Einsatz, die vor Jahrzehnten in den meisten Anwendungsbereichen Keramiksubstrate abgelöst hatten. Inzwischen stoßen sie jedoch in ausgewählten Zukunftssegmenten zunehmend an ihre Grenzen. Prominente Bereiche hierfür sind etwa High-End-Prozessoren für Rechenzentren mit mehreren Halbleiterchips auf einem Substrat sowie die neuen KI-Rechenboliden mit ihrem extremen Hunger nach Leistung und Datendurchsatz. An der Entwicklung der Glaskernsubstrat-Technologie sind nicht nur Branchenriesen wie Intel und Samsung beteiligt, sondern auch z. B. das Start-up Absolics, eine Tochtergesellschaft der koreanischen SKC. Kernaufgaben der Substrate sind die mechanische Stabilisierung der auf ihnen montierten Halbleiterchips, die erforderliche Verdrahtung der Chips untereinander und die elektrischen Verbindungen zur Außenwelt (Motherboard). Leiterbahnen und Verbindungslöcher (Vias) sind die wesentlichen Strukturelemente.
Vorteile der Glaskernsubstrate
Silicium und Glas haben – im Gegensatz zu organischen Substraten – sehr ähnliche thermische Ausdehnungskoeffizienten. Temperaturwechsel im Betrieb sowie in der Herstellung führen zu Ausdehnungen und Schrumpfungen, die bei den besser angepassten Glaskernsubstraten zu deutlich weniger Stress führen. Da die Oberflächen der Glaskernsubstrate deutlich glatter sind als diejenigen der organischen Substrate, können wesentlich feinere Strukturen realisiert werden. Das betrifft sowohl Leiterbahnen als auch Vias. So können die neuartigen Substrate gemäß Intel etwa 50 % mehr Halbleiterchips aufnehmen als die organischen Substrate. Laut Intel liegt bei den neuen Glaskernsubstraten die maximale Packagegröße bei 240 mm x 240 mm im Gegensatz zu etwa 120 mm x 120 mm bei organischen Substraten, sodass sich die max. Fläche vervierfacht, was insbesondere bei High-End-Prozessoren für Rechenzentren (HPC) und KI-Chips neue Möglichkeiten eröffnen wird. Schmale Cu-Leiterbahnen, eng gestaffelte Glas-Vias und extrem geringe dielektrische Verluste des Glasmaterials erlauben höhere Signalfrequenzen/Datenraten.
 Beispiele für Prozesse zum lasergestützten Ätzen von Glaskernen
Beispiele für Prozesse zum lasergestützten Ätzen von Glaskernen
Herausforderungen
Rahul Manepalli, Leiter der Entwicklungsabteilung von Substrat-Packaging-Technologie bei Intel, spricht aber auch Stolpersteine von Glas als Substratmaterial an: „Es bringt sehr anspruchsvolle Integrations- und Schnittstellenprobleme mit sich, die wir lösen müssen.“[1] Dazu zählen Zerbrechlichkeit, die problematische Haftung an Metall(drähten) und die Schwierigkeit, eine gleichmäßige Durchkontaktierung für gleichbleibende elektrische Leistung (P) zu erzeugen. Auch unterscheidet sich Glas durch seine Transparenz und ein anderes Reflexionsverhalten grundlegend von Silicium, sodass Mess- und Inspektionsverfahren, die bei un- und halbdurchsichtigen Materialien angewendet werden, keine oder nur teilweise belastbare Ergebnisse bringen. Die Lichtdurchlässigkeit von Glas kann bei optischen Messungen etwa zu Signalverzerrungen oder -verlusten führen. Keith Best, Director Product Marketing des amerikanischen Halbleiterherstellers Onto Innovation, fasste die Herausforderungen im September 2023 in einem Blogeintrag für die Webseite ‚Semiconductor Engineering' zusammen: „Glas ist zerbrechlich, vor allem bei den großen Formen, die heute verwendet werden (510 mm x 515 mm und 600 mm x 600 mm). Außerdem ist das Glassubstrat sehr dünn, in einigen Fällen < 100 μm.“ Um die Bruchgefahr zu minimieren, seien hoch entwickelte Geräte zur Bearbeitung und Handhabung nötig. Als Kompromiss bezeichnet Keith Best eine Hybridlösung, bei der die großen RDL-Strukturen mit dem CCL-Basisverfahren und feine RDL auf einem Glassubstrat strukturiert werden, das mithilfe von winzigen Cu- Bondhügeln (Mikrobumps) auf dem CCL befestigt wird. [2]
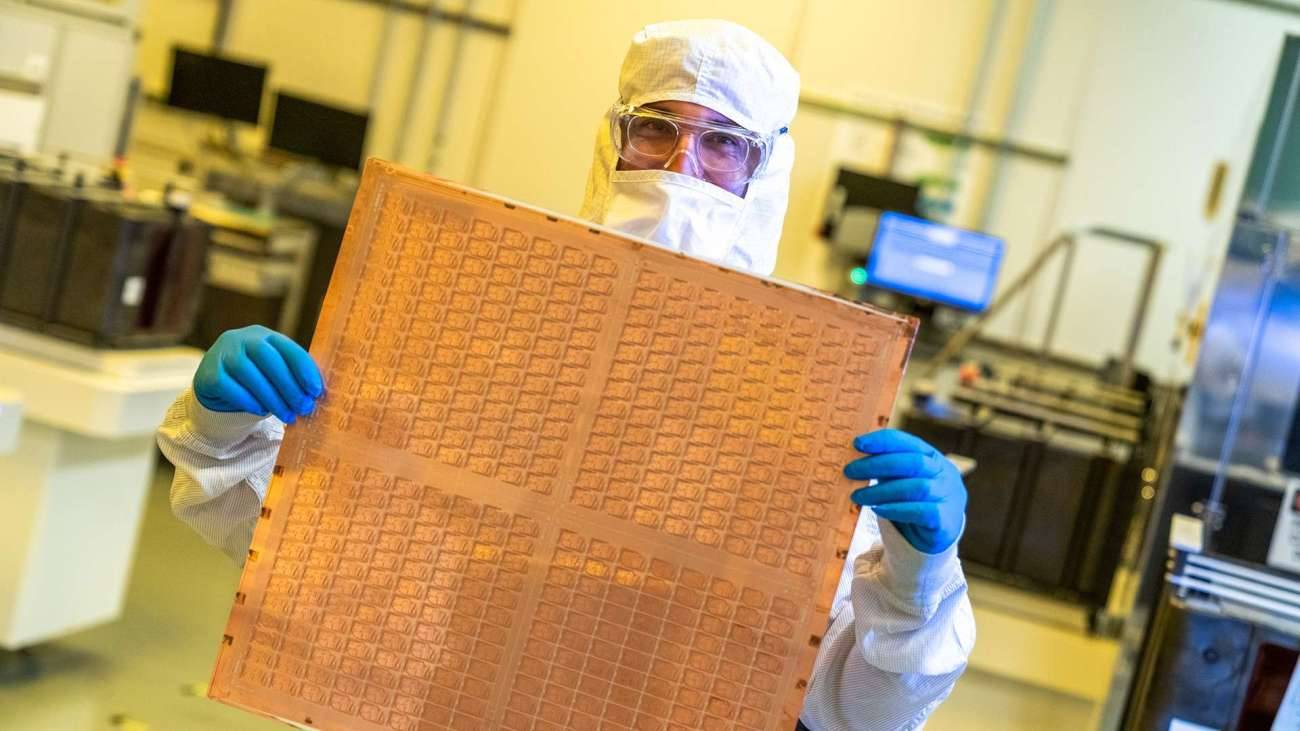 Glaskernsubstrat von Intel, präsentiert im Juli 2023 in Chandler, Arizona (USA)
Glaskernsubstrat von Intel, präsentiert im Juli 2023 in Chandler, Arizona (USA)
Glaskernsubstrate im Aufschwung
Der Markt für Advanced IC-Substrate wird laut Marktanalysen der Yole Group, einem Marktforschungsunternehmen aus Lyon (Frankreich), im Jahr 2024 voraussichtlich einen Wert von 16,6 Mrd. $ erreichen und im Zeitraum 2024 bis 2029 eine durchschnittliche jährliche Wachstumsrate (CAGR) von 9 %.[3] Bei der Vermarktung von Glaskernsubstraten hätten sich neue Akteure dem Wettbewerb gestellt. Yole zählt dazu Absolics sowie die etablierten Firmen Intel und Samsung. Das prognostizierte Wachstum wird laut Yole durch die steigende Nachfrage nach Flip-Chip-Ball-Grid-Array-Substraten und fortschrittlichen 2,5D/3D-Gehäusen angetrieben. Zum Einsatz kommen sie bei Hochleistungsrechnern und Rechenzentren, 5G, CPUs und XPUs für KI-Personalcomputer sowie im Automobilsektor. Kommende Marktteilnehmer werden vor allem auf Unternehmen der KI-Branche fokussieren. Die Herstellung fortschrittlicher IC-Substrate konzentriere sich vor allem in Taiwan, Japan und Südkorea, so äußerte sich Bilal Hachemi, Analyst bei Yole. Auch China habe seit 2021 nach Investitionen erhebliche Fortschritte erzielt und werde künftig Marktanteile hinzugewinnen, insbesondere bei FCBGA-Substraten. Die Lieferkette für Substrate in den USA entwickele sich hingegen nur langsam. Dies änderte sich allerdings durch ein Förderprogramm der Regierung zur Substratherstellung in den USA. Yole geht jedoch davon aus, dass die Produktion von Advanced IC-Substrates weiterhin in Asien konzentriert sein wird. So investiert die Firma Zhen Ding mit dem Hauptsitz in Taiwan bis 2027 über 1 Mrd. $, um ein globaler Anbieter von High-End-Substraten zu werden. Zhen Ding führte die Liste der weltweit größten Leiterplattenhersteller im NTI-100-Report 2023 an.[4]
www.intel.de, www.absolicsinc.com, www.ontoinnovation.com, www.yolegroup.com
Referenzen
[1] https://semiengineering.com/the-race-to-glass-substrates/ (Abruf: 27.10.2024).
[2] https://ontoinnovation.com/writable/files/Intelligent-Innovation-The-Glass-Substrate-Formatted.pdf (Abruf: 27.10.2024).
[3] https://www.yolegroup.com/press-release/advanced-ic-substrate-industry-exciting-developments-on-the-horizon/ (Abruf:21.10.2024).
[4] PLUS 10/2024, S. 1220ff.