The ever-increasing demands on performance and reliability in the semiconductor industry, combined with short time to market, raise the demand for alternative accelerated testing methods. In this context, the BAMFIT-tester was recently introduced as an extremely fast and efficient method for qualification and determination of the lifetime of wire bonds. This paper presents a practical method for direct comparison of wire bond degradation by the mechanical BAMFIT test and accelerated power cycling. Thereby, master curves are created that enable an extremely fast determination of the remaining lifetime and a realistic and reliable lifetime prognosis for semiconductor modules by using the BAMFIT test.
Einführung
Das Ultraschall-Dickdrahtbonden ist nach wie vor eine der wichtigsten Verbindungstechnologien für Leistungshalbleiter, wie z. B. IGBT-Module, da es sich durch Flexibilität, hohe Prozesskontrolle und niedrige Produktionskosten auszeichnet. Die leistungselektronischen Systeme werden zunehmend in der Stromerzeugung und -verteilung, im Schienenverkehr, in der Automobilindustrie und in der Steuerungstechnik eingesetzt, wobei die Anforderungen an hohe Leistung und lange Lebensdauer steigen. Die Halbleitermodule sind in der Regel in einer mehrschichtigen planaren Struktur aufgebaut, bei der mehrere Komponenten für ein effektives Wärmemanagement und strukturelle Integrität kombiniert werden. Aufgrund des unterschiedlichen thermischen Ausdehnungskoeffizienten (CTE) der verschiedenen Materialien kommt es dabei bei hohen Temperaturen zu unterschiedlichen Ausdehnungs- und Kontraktionsraten, die auf die Verlustleistung der Halbleiterbauteile während des Betriebs oder auf Temperaturschwankungen in der Umgebung sowie auf die Joule-Erwärmung der Drahtbonds während des Stromflusses zurückzuführen sind. Diese wiederholte zyklische Erwärmung und Abkühlung des Moduls verursacht thermisch-mechanische Spannungen und Dehnungen, die zur Rissbildung und zum Risswachstum und anschließend zum Abheben der Bonds führen. Außerdem kann die Biegung der Bonddrähte während des Stromflusses und des Temperaturanstiegs dazu führen, dass sich Risse im Heel-Bereich des Drahtes bilden, was zu so genannten „Heel Cracks“ führt. Ein Versagen der Drahtbonds und der Lötstellen kann die Stromdichteverteilung in den Leistungsbauteilen verändern, was wiederum zu einem erhöhten elektrischen und thermischen Widerstand und schließlich zu einem katastrophalen Ausfall der Module während des Betriebs bzw. der Power Cycling (PC) oder Temperaturwechseltests (TC) führt [1, 2]. Um zuverlässige und robuste Produkte zu realisieren, ist daher die Vorhersage der Zuverlässigkeit von Leistungsmodulen in der Entwicklungs- und Produktionsphase unter Berücksichtigung dieser potenziellen Schwachstellen von entscheidender Bedeutung.
Aluminium-Dickdrahtbonds können die Anforderungen an eine zuverlässige Kontaktierung von Leistungshalbleitern mit höheren Lastströmen auf Dauer nicht erfüllen, weswegen alternative planare Montagekonzepte hinsichtlich ihrer Serientauglichkeit, Zuverlässigkeit und Kostenattraktivität noch weiterentwickelt werden müssen. Daher wird die material- und prozesstechnische Weiterentwicklung der Drahtbondtechnologie vorangetrieben, um die Leistungsfähigkeit und Stabilität der Emitter Kontaktierung (Draht-Metallisierungsgrenzfläche) von Halbleitern zu erhöhen [3]. Das sogenannte Ribbon-Bonden ermöglicht eine großflächige Kontaktierung der Leistungshalbleiter und damit eine höhere Stromdichte und verbesserte Stromverteilung auf dem Halbleiter. Mit nur geringen Anpassungen des Bondprozesses kann die Prozesszeit reduziert und eine höhere Produktivität erreicht werden. Auf der anderen Seite gibt es aufgrund der vorgegebenen Geometrien und der höheren Steifigkeit einige Einschränkungen beim Layout. Um eine deutlichere Steigerung der Zuverlässigkeit in Verbindung mit einer hohen Designflexibilität erzielen zu können, wurden unter anderem legierte Al-Drähte mit höherer Temperaturstabilität, Aluminium-Kupfer-Core-Drahtbonds und Kupferdraht Bonding eingeführt, wobei letzteres einen wachsenden Anteil an den Verbindungstechnologien in der Leistungselektronik hat. Als Alternativen kommen auch Aluminium-Kupfer-Bändchen und reine Kupferbändchen in Frage [4].
Während auf der Produktionsseite die oben genannten alternativen Materialien deutlich höhere Anforderungen an die Bestimmung und Optimierung von Prozess- und Produktionsparametern stellen, kann jede neue Verbindungskombination die Lebensdauer der Leistungshalbleiter drastisch beeinflussen. Daher ist es neben der erforderlichen Prozessoptimierung von entscheidender Bedeutung, die Ermüdung und langfristige Zuverlässigkeit der Verbindungsschnittstellen als einen der Hauptausfallmechanismen in IGBT-Modulen in frühen Entwicklungsstadien zu bestimmen.
Die derzeitige Standardmethode zur Bewertung der Zuverlässigkeit von Bauteilen ist der Power-Cycling-Test (PC), der in den letzten drei Jahrzehnten ausführlich zur Bewertung der Zuverlässigkeit von Drahtverbindungen, insbesondere der klassischen Al-Drähte, verwendet wurde. Der häufig verwendete Ansatz zur Zuverlässigkeitsbewertung auf der Grundlage der Ausfallphysik (PoF) basiert auf der Vorhersage der Zyklenzahl (Nf) bis zum Ausfall (Abheben, Heel-Crack und Lötstellenversagen für ein bestimmtes Anwendungsprofil) unter Verwendung von Schadensparametern, wie z. B. Temperaturbereich, Spannung, Dehnung und Kriechen unter der aufgebrachten Last, die durch die Finite-Elemente-Analyse (FEA) ermittelt werden. Mit dieser Methode werden häufig Lebensdauervorhersagen getroffen, die weit von den Testergebnissen abweichen, weil der eigentliche Versagensmechanismus, nämlich das Risswachstum, nicht einbezogen oder berücksichtigt wird. Daher haben sich mehrere Studien in letzter Zeit auf die Entwicklung experimenteller und numerischer Ansätze konzentriert, um das Risswachstum an der Draht-Metallisierungsgrenzfläche in den Lebensdauermodellen zu berücksichtigen und realistischere Lebensdauerprognosen erstellen zu können [5–8].
Als ein völlig neuer Ansatz, wurde der BAMFIT-Tester (Bondtec Accelerated Mechanical Fatigue Interconnection Test) für die rasche Lebensdauerbewertung von den Bonddrähten vorgestellt [9–11]. Das Prüfsystem ist mit einem speziellen Resonanz-Test-Tool ausgestattet, das lokale zyklische Scherspannungen an der Verbindungsstelle induziert, um so die thermomechanischen Belastungen während des Schaltvorgangs nachzubilden, die zum Abheben des Drahtbonds führen. Durch die Erhöhung der mechanischen Prüffrequenz bis in den kHz-Bereich wird eine extrem hohe Beschleunigung erreicht, sodass Lebensdauerkurven in sehr kurzer Zeit erstellt werden können. Das Prüfsystem und die Testschritte von BAMFIT sind in Abbildung 1a–e dargestellt. Der BAMFIT Bondtester ist bereits auf dem Markt erhältlich [12] und nähere Informationen zu den Testprinzipien und dem Testgerät sind in [11] erläutert.
 Abb. 1: F&S Bond-Tester (a) und der BAMFIT-Testkopf (b) und sein Funktionsprinzip: die Resonanzpinzette klemmt den Cu-Cu-wedge ein (c), Abheben des Drahtbonds nach der zyklischen Belastung (d) und Footprint des Cu-Cu- Wedgebonds nach dem Ermüdungstest (e)
Abb. 1: F&S Bond-Tester (a) und der BAMFIT-Testkopf (b) und sein Funktionsprinzip: die Resonanzpinzette klemmt den Cu-Cu-wedge ein (c), Abheben des Drahtbonds nach der zyklischen Belastung (d) und Footprint des Cu-Cu- Wedgebonds nach dem Ermüdungstest (e)
In den vorangegangenen Studien konnte zeigt werden, dass die BAMFIT-Methode erfolgreich zur Bewertung der Qualität und zum Vergleich der Lebensdauer von Drahtbondverbindungen für verschiedene Arten von Drahtmaterial und Metallisierung Kombinationen sowie Bond- und Prozessparametern eingesetzt werden kann. So wurden beispielsweise vergleichende Studien zu Al, AlMg, Al-beschichtetes Cu (CucorAl) und Cu Dickdrahtbonds auf verschiedenen Chips und Substraten durchgeführt [11, 13]. Abbildung 2a, b zeigt ein Beispiel der Lebensdauerkurven von Cu-Dickdrahtbonds auf Cu-Metallisierung unter verschiedenen Bedingungen [11, 13]. Um die Einflüsse von Temperatur und Gefügeveränderungen auf die Zuverlässigkeit der Verbindungen zu ermitteln, wurden die Cu-Cu-Verbindungen im Ausgangszustand bei Raumtemperatur und bei einer erhöhten Temperatur von 200°C sowie nach einer zweiwöchigen Alterung bei 200°C geprüft. Ein Vergleich der Bruchwahrscheinlichkeitskurven der drei Testreihen zeigt, dass die Alterung keinen Einfluss auf die Lebensdauer der Cu-Cu Verbindungen hat, aber die isotherme Prüfung bei 200°C die Lebensdauer der Drahtbonds im Durchschnitt um etwa die Hälfte verringert [11]. Dabei ist zu beachten, dass bei einer derzeit maximalen Betriebstemperatur von Cu-Leistungsmodulen von 175 °C eine Testtemperatur von 200 °C als sehr harte Belastung angesehen wird.
Zusätzlich zu den Dickdrahtbonds konnte in weiteren Studien mit einer speziell entwickelten Resonanzpinzette, die für die Prüfung sehr feiner Bonddrähte bis hinunter zu 25 µm ausgelegt ist, die Grenzflächenzuverlässigkeit durch die Ermüdung der Bondgrenzfläche und Lift-off-Versagen an verschiedenen Nailheads von Thermosonic-Bonds ermittelt werden [14]. Die exemplarische Lebensdauerkurve in Abbildung 2c zeigt einen Vergleich zwischen dem Ermüdungsverhalten von Cu-Drahtbonds mit einem Drahtdurchmesser von 65µm auf der Cu- oder Al-Metallisierung in kommerziellen Chips.
 Abb. 2: Einfluss der Prüftemperatur und der Alterung auf die mechanischen Zuverlässigkeitskurven von Cu-Cu-Drahtbonds (a, b) Vergleich der Lebensdauerkurven von Cu-Cu (rot) und Cu-Al (blau) 65 μm Thermosonic ballbonds (c)
Abb. 2: Einfluss der Prüftemperatur und der Alterung auf die mechanischen Zuverlässigkeitskurven von Cu-Cu-Drahtbonds (a, b) Vergleich der Lebensdauerkurven von Cu-Cu (rot) und Cu-Al (blau) 65 μm Thermosonic ballbonds (c)
In einer weiteren Reihe von Studien wurde das Ermüdungs- und Degradationsverhalten der Drahtbonds unter beschleunigten Power Cycling und mechanischer Ermüdungstest aus qualitativer Sicht verglichen [10, 15]. Abbildungen 3a, b und c zeigen einen Überblick über die Prüfergebnisse von 4 Serien von 400µm Al-wedge-bonds, die mit unterschiedlichen Bondleistungen hergestellt wurden. Die Schertests zeigen einen Anstieg der Haftfestigkeit bei Erhöhung der Ultraschall-Leistung von 100 auf 120 %, wobei diese bei weiterer Erhöhung nahezu konstant bleibt (Abb. 3a). Die Werte der Scherfestigkeit (Abb. 3a) und des mechanischen Ermüdungstests (Abb. 3b) werden in Boxplots dargestellt, die eine Streuung der Daten für beide Fälle zeigen. Im Gegensatz dazu, zeigen die Ergebnisse der mechanischen Ermüdungstests, die bei einer konstanten Auslenkungsamplitude von (Abb. 3b) durchgeführt wurden, und die Daten der Power-Cycling-Tests bei (Abb. 3c) im Zyklenbereich von 1e5 bis 3e5 einen ähnlichen Anstieg der Lebensdauer (Nf) mit zunehmender Bondleistung.
Jeder Datenpunkt im PC-Plot repräsentiert ein ausgefallenes Modul mit ~400 internen IGBT-Drahtbonds, wobei das Ausfallkriterium der Anstieg der Kollektor-Emitter-Spannung VCE auf 0,5V war, bei dem mehrere Einzelbondverbindungen bereits vollständig getrennt wurden. Der Zeitaufwand für die parallelle Durchführung der PC-Tests für die 9 Module betrug etwa drei Monate. Für jeden Boxplot des mechanischen BAMFIT-Tests wurden 64 Drahtbonds getestet. Die Testzeit für den gesamten Datensatz (Abb. 3b), bestehend aus 265 Bonds im Bereich von 1e5-5e6 Nf, wurde in weniger als 1 Stunde ermittelt. Der ähnliche Trend der Ergebnisse der elektischen Lastwechsel (PC)- und mechanischen BAMFIT Ermüdungsprüfung der unter den gleichen Bedingungen hergestellten Drahtbonds, bestätigt die Zuverlässigkeit von BAMFIT als hocheffiziente alternative Bewertungsmethode. Darüber hinaus zeigen die vorgestellten Daten, dass die Verwendung statischer Prüfverfahren für die Bewertung von Komponenten, die im Realfall zyklischen Belastungen ausgesetzt sind, nicht unbedingt aussagekräftig ist.
![Abb. 3: Vergleichstest an 400μm Al-Wedgebonds mit Schertests (a), beschleunigten mechanischen Tests BAMFIT (b) und PC-Tests (c) [11] Abb. 3: Vergleichstest an 400μm Al-Wedgebonds mit Schertests (a), beschleunigten mechanischen Tests BAMFIT (b) und PC-Tests (c) [11]](/images/stories/Abo-2023-10/plus-2023-10-066.jpg) Abb. 3: Vergleichstest an 400μm Al-Wedgebonds mit Schertests (a), beschleunigten mechanischen Tests BAMFIT (b) und PC-Tests (c) [11]
Abb. 3: Vergleichstest an 400μm Al-Wedgebonds mit Schertests (a), beschleunigten mechanischen Tests BAMFIT (b) und PC-Tests (c) [11]
Die oben kurz dargestellten Beispiele zeigen die Vorteile der beschleunigten mechanischen Ermüdungsprüfung für eine Vielzahl von Anwendungen, wie Zuverlässigkeitsbewertung von Dünn und Dick-Drahtbonds auf Halbleitern, Interfaceanalyse von Drahtbonds auf verschiedenen Oberflächen und die Bewertung der Scherfestigkeit des Bondinterface zur Materialcharakterisierung. Letzens wurde der BAMFIT-Tester auch für die Bestimmung der Loop-Festigkeit in Abhängigkeit von Prozessparametern von Bondern eingesetzt [16].
Die folgende Studie gibt einen Überblick über eine umfassende Vergleichsstudie zum Degradationsverhalten von Al-Drahtbonds unter beschleunigter thermischer und mechanischer Belastung. Dazu wurde das Risswachstumsverhalten von Al-Drahtbonds in kommerziellen IGBT-Modulen während der Wechselbelastung bis hin zum vollständigen Ausfall mit der BAMFIT-Methode bei 60kHz und den konventionellen beschleunigten Power Cycling Tests (PC) eingehend untersucht und die Ergebnisse wurden qualitativ und quantitativ verglichen [17].
Lebensdauer und der Schädigungsgrad von Drahtbonds
Die Untersuchungen wurden mit standardmäßigen Six-Pack-Trench-Field-Stop-IGBT-Modulen durchgeführt (econoPACK™3 series) (Abb. 4a). Die Verbindungen zwischen den Bauelementen bestehen aus (16x8) ultraschallgebondeten 400-µm-Al-Drähten auf der Aluminium-Metallisierung der IGBT-Chips, die sich auf Direct Copper Bonded (DCB)-Substraten befinden. Der PC-Aufbau wurde so konfiguriert, dass zwei Bauelemente getrennt belastet werden und die „Einschaltspannung“ und die Sperrschichttemperatur und direkt während des gesamten Tests mit einem Lichtleitersensor überwacht werden. Ein VCE-Anstieg von 5 % wurde als Indikator für einen Ausfall des Moduls (End-of-Life / EOL) aufgrund des Abhebens der Drahtbonds festgelegt. Der erhöhte Strom in den verbleibenden Bonddrähten erzeugt einen lokalen Hotspot um die verbleibenden Verbindungen auf dem Chip. Die PC-Tests wurden in Kooperation mit der Universität Aalborg durchgeführt [17, 18] und die Einzelheiten sind in [7] zu finden.
Beim PC-Test mit einer eingestellten Sperrschichttemperaturdifferenz ( von 60 °C wurden die Module zwischen 140 °C und 80 °C belastet, wobei das End of Life im Durchschnitt bei etwa N~3e5 Zyklen aufgrund von Drahtbond-Lift-off erreicht wurde. Um das Risswachstumsverhalten der Drahtbonds während des PC-Tests zu untersuchen, wurden mehrere Module bis etwa 30, 50 und 70 % des EOL mit Bezug auf die ermittelte durchschnittliche Lebensdauer geprüft. Die Entwicklung der getesteten IGBTs in den verschiedenen Phasen der Lebensdauer ist in Abbildung 4b dargestellt. Die entsprechenden Lebensdauerdaten sind als tatsächlich gemessen ΔTJ Werten in Abhängigkeit von den Zyklenzahlen dargestellt (farbige Symbole in Abb. 4c). Die erhaltenen Daten stimmen sehr gut mit den früher berichteten PC-Lebensdauern von ähnlichen Standardmodulen überein [19] (Abb. 4c). Die mechanischen Ermüdungstests der Al-Drahtbonds wurden bei Verschiebungsamplituden (Δx) von etwa 100 bis 600nm im Bereich von 1e4 bis 2e8 Zyklenzahlen mit jeweils mindestens 25 Drahtbonds durchgeführt (graue Symbole in Abb. 5a) wobei die ermittelte 50%ige Ausfallwahrscheinlichkeitskurve als EOL-Kurve für die Bonddrähte definiert (gestrichelte Kurve in 5a) wurde. Unter Bezugnahme auf diese Kurve, wurden weitere intermittierende Tests im Bereich von 300 bis 600nm bei jeweils 30%, 50% bzw. 70% des EOL durchgeführt (farbige Symbole in Abb. 5a).
![Abb. 4: Kommerzielles IGBTModul, Infineon econoPACK™3 1200V, 150A (a), VCE-Entwicklung während der PC-Test für die bis zu 30 %, 50 %, 70 % und 100 % des EOL getesteten Module (b) [7, 18], PC-Daten für die bis zu 30 %, 50 %, 70 % und 100 % des EOL getesteten Module (farbige Symbole) im Vergleich zur Lebensdauerkurve ähnlicher Module aus [19] (c) Abb. 4: Kommerzielles IGBTModul, Infineon econoPACK™3 1200V, 150A (a), VCE-Entwicklung während der PC-Test für die bis zu 30 %, 50 %, 70 % und 100 % des EOL getesteten Module (b) [7, 18], PC-Daten für die bis zu 30 %, 50 %, 70 % und 100 % des EOL getesteten Module (farbige Symbole) im Vergleich zur Lebensdauerkurve ähnlicher Module aus [19] (c)](/images/stories/Abo-2023-10/plus-2023-10-070.jpg) Abb. 4: Kommerzielles IGBTModul, Infineon econoPACK™3 1200V, 150A (a), VCE-Entwicklung während der PC-Test für die bis zu 30 %, 50 %, 70 % und 100 % des EOL getesteten Module (b) [7, 18], PC-Daten für die bis zu 30 %, 50 %, 70 % und 100 % des EOL getesteten Module (farbige Symbole) im Vergleich zur Lebensdauerkurve ähnlicher Module aus [19] (c)
Abb. 4: Kommerzielles IGBTModul, Infineon econoPACK™3 1200V, 150A (a), VCE-Entwicklung während der PC-Test für die bis zu 30 %, 50 %, 70 % und 100 % des EOL getesteten Module (b) [7, 18], PC-Daten für die bis zu 30 %, 50 %, 70 % und 100 % des EOL getesteten Module (farbige Symbole) im Vergleich zur Lebensdauerkurve ähnlicher Module aus [19] (c)
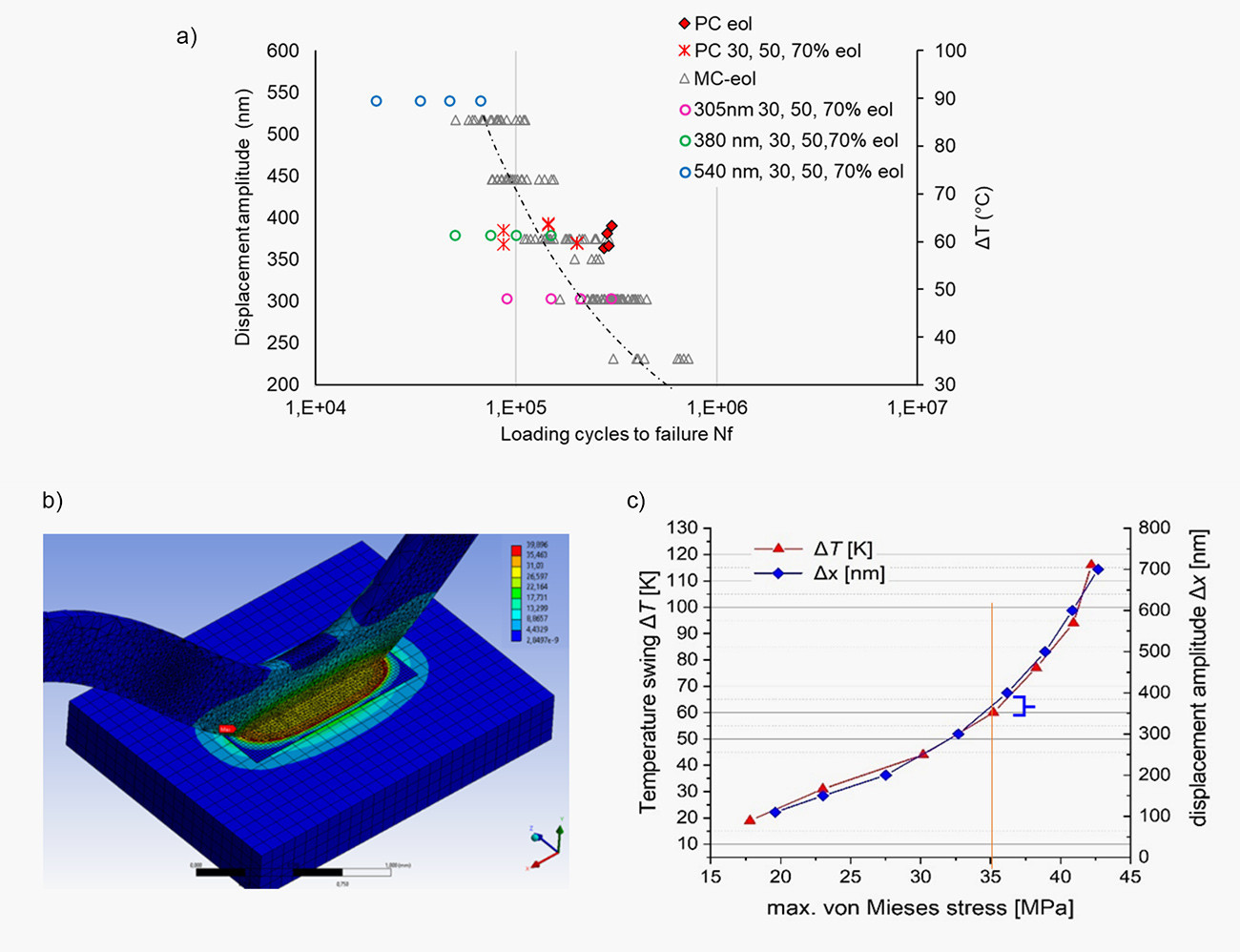 Abb. 5: Korrelation der PC-Lebensdauerdaten mit den Ermüdungskurven des BAMFIT-Tests, einschließlich der intermittierenden Datenpunkte (a), Die Beziehung zwischen der Temperaturdifferenz (ΔTJ), der mechanischen Verschiebung (Δx) und dem Maximum der durch FEM-Simulationen berechneten von-Mises-Spannung an der Verbindungsstelle
Abb. 5: Korrelation der PC-Lebensdauerdaten mit den Ermüdungskurven des BAMFIT-Tests, einschließlich der intermittierenden Datenpunkte (a), Die Beziehung zwischen der Temperaturdifferenz (ΔTJ), der mechanischen Verschiebung (Δx) und dem Maximum der durch FEM-Simulationen berechneten von-Mises-Spannung an der Verbindungsstelle
Mittels einer elektro-thermisch-mechanischen Finite-Elemente-Simulation wurde die Korrelation der mechanischen Verschiebungsamplitude (Δx) mit dem entsprechenden Temperaturbereich des PC-Tests ermittelt [10]. Abbildung 5b zeigt den Verlauf der v. Mises-Spannungs-Verteilung in einem Drahtbond, der bei mechanischer Belastung einer Verschiebungsamplitude von Δx ausgesetzt ist, wobei das Maximum der Grenzflächenspannungen an den Randbereichen auftritt. Dabei liefert die vorliegende Simulation, unter vereinfachten Bedingungen, eine gute Annäherung an die maximale Spannung an der kritischen Stelle der Verbindungen. Nach Bestimmung der thermischen und mechanischen Belastungsbedingungen, die zum gleichen Wert der v. Mises-Spannung führen, konnte die mechanische Ermüdungskurve mit den PC-Daten korreliert werden. Nach diesen Berechnungen entspricht ein nominales ΔTJ ~ 60K einem Δx von ~ 380 nm auf der mechanischen EOL-Kurve mit einer Spitzenspannung von etwa 35MPa an den Randbereichen der Verbindung in jeweils beiden Fällen (Abb. 5c). Einen Vergleich zwischen den Prüfbedingungen und der Dauer der intermittierenden Prüfungen bei PC- und mechanischen Ermüdungstest mit BAMFIT ist in Tabelle 1 gegeben.
|
BAMFIT test 60kHz |
Power cycling test |
|||||
|
EOL |
kcycles |
Time |
Δx [nm] |
kcycles |
Time |
ΔTJ [K] nominal |
|
100 % |
300 |
~5,1 s |
380 |
286.425 |
13 days 6 h 15 min |
59-63 |
|
70 % |
210 |
3,6 s |
380 |
200.37 |
9 days 6 h 38 min |
58-60 |
|
50 % |
150 |
2,6 s |
380 |
144.71 |
6 days 16 h 48 min |
64 |
|
30 % |
90 |
1,55 |
380 |
86.83 |
4 days 30 min |
59-62 |
Die Bondstellen wurden dann mittels Metallographie und 3D-Röntgentomographie untersucht, um den Grenzflächenschädigung in verschiedenen Phasen der thermischen und mechanischen Ermüdung zu bestimmen. Darüber hinaus wurden die Drahtbonds mittels statischer Scherversuche mit anschließender Bruchflächenanalyse mittels Licht- oder Rasterelektronenmikroskopie untersucht. Die Abbildungen 6a–e zeigen beispielhafte rasterelektronenmikroskopische Aufnahmen der gescherten Drahtbonds vor dem Ermüdungstest (Abb. 6a) und in verschiedenen Ermüdungsstadien bis zum vollständigen Abheben (Abb. 6e) nach BAMFIT-Tests. Dabei ist die Abnahme der verbleibenden Bondfläche (remaining bond area) mit zunehmender Zyklenzahl deutlich zu erkennen. Der Zusammenhang zwischen der (gemittelten) verbleibenden Verbindungsfläche nach mechanischer Ermüdungsbelastung bei verschiedenen Verschiebungsamplituden und der Zyklenzahlen ist in Abbildung 6f dargestellt. Aus diesen Kurven ist auch ersichtlich, dass das Risswachstum oder die Delaminierung zunächst relativ langsam verläuft und mit zunehmender Amplitude der beschleunigten mechanischen Tests stark ansteigt. Ein ähnlicher Trend wurde für die PC-Tests in einem breiteren ΔTJ-Bereich berichtet [22] und ebenfalls wie unten dargestellt, in dieser Studie beobachtet.
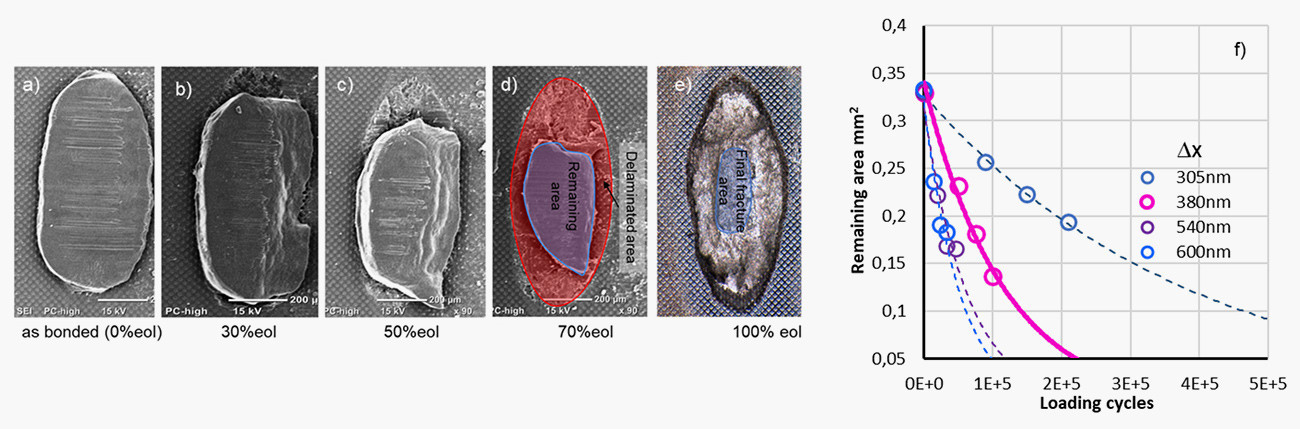 Abb. 6: REM-Aufnahmen der abgescherten Drahtbonds im Ausgangszustand (nicht belastet) und nach mechanischer Ermüdung bei Δx=320nm bis zu 30 %, 50 %, 70 % und 100 % des EOL (a-e), Risswachstumskurven dargestellt als die Verhältnisse zwischen den verbleibenden Bondflächen und den Zyklenzahlen nach dem BAMFIT-Test erstellt mit den Daten der 50%igen Bruchwahrscheinlichkeitskurve (f)
Abb. 6: REM-Aufnahmen der abgescherten Drahtbonds im Ausgangszustand (nicht belastet) und nach mechanischer Ermüdung bei Δx=320nm bis zu 30 %, 50 %, 70 % und 100 % des EOL (a-e), Risswachstumskurven dargestellt als die Verhältnisse zwischen den verbleibenden Bondflächen und den Zyklenzahlen nach dem BAMFIT-Test erstellt mit den Daten der 50%igen Bruchwahrscheinlichkeitskurve (f)
Um diesen Zusammenhang für die Drahtbonds nach PC-Tests zu ermitteln, wurden mehrere IGBTs auf den getesteten Modulen untersucht. Dabei wurde, wie in Abbildung 7 beispielhaft dargestellt, eine deutliche Variation zwischen der Degradationsrate und der Position des Drahtbonds auf dem IGBT festgestellt.
 Abb. 7: Das Bild eines IGBTs zeigt die Position der Temperatursensoren und der Bondnummern. Die REM-Aufnahmen der abgescherten Oberfläche der Drahtbonds nach dem Power Cycling bis zu 50 % der Lebensdauer zeigen eine starke Variation der verbleibenden Bondfläche in Abhängigkeit von der Bondposition
Abb. 7: Das Bild eines IGBTs zeigt die Position der Temperatursensoren und der Bondnummern. Die REM-Aufnahmen der abgescherten Oberfläche der Drahtbonds nach dem Power Cycling bis zu 50 % der Lebensdauer zeigen eine starke Variation der verbleibenden Bondfläche in Abhängigkeit von der Bondposition
Es wurde bereits in mehreren Studien berichtet, dass die Temperatur in den verschiedenen Teilen der IGBT-Module während des Power-Cycling-Tests ungleichmäßig verteilt ist [z. B. 20, 21]. Zuletzt wurde die Temperaturverteilung in den econoPACK™3-Modulen während des PC-Tests unter denselben Bedingungen, wie in der vorliegenden Studie ermittelt [7]. Anhand von direkten Temperaturmessungen auf der Chipoberfläche und FEM-Simulationen wurde festgestellt, dass je nach Position der Bonds und ihrer Nähe zur Chipmitte eine Abweichung von etwa 24 % zwischen der Temperatur des heißesten und des kältesten Bonds zu erwarten ist. Daraus ergibt sich ein Anstieg von mehr als 20 K im Vergleich zum eingestellten ΔTJ von 60K. Abbildung 8a zeigt, dass die Restscherfestigkeitswerte der verbleibenden Verbindungsfläche für jede Verbindung nach dem PC-Test sehr gut mit der Lage der Verbindung und der jeweiligen relativen Temperatur während des Tests korrelieren. Es ist deutlich zu beobachten, dass die Risswachstumsrate mit dem Anstieg der Sperrschichttemperatur der Verbindungen von der Peripherie zur Mitte des Chips zunimmt und dadurch zu einer inhomogenen Degradationsrate je nach der Lage der Bondstellen auf der IGBT führt.
Die Auswertung der verbleibenden Bondflächen in Abhängigkeit von ihrer Position auf dem IGBT ergaben wiederum die sogenannten Risswachstumskurven (Abb. 8b). Basierend auf den berechneten Temperaturschwankungen des Chips [7] wurde die Sperrschichttemperatur aller Drahtbonds in drei ΔTJ-Bereiche von 60 ± 4K, 70 ± 4K und 80 ± 3K je nach ihrer Lage auf dem IGBT-Chip unterteilt. Damit kann die verbleibende Verbindungsfläche des Drahtbonds in Abhängigkeit von einem durchschnittlichen ΔTJ-Bereich als Funktion der Belastungszyklen (% EOL) bestimmt werden (Abb. 8b). Aufgrund der starken Bond-Degradation bzw. Vorhandensein mehrerer Lift-offs wurden die Auswertung bei 70 % des EOL, in dieser Darstellung nicht berücksichtigt.
![Abb. 8: Verhältnis zwischen der effektiven Temperatur jede Bondstelle und die Bondstelle mit der höchsten Temperatur (Bond11nach [7]) in Korrelation mit den Verhältnissen der verbleibenden Scherfestigkeit und der verbleibenden Bondfläche zu den jeweiligen ursprünglichen Werten nach dem PC-Test bis 50 % von LOI (a), Risswachstumskurven dargestellt als die Verhältnisse zwischen den verbleibenden Bondflächen und den Zyklenzahlen nach dem PC-Test (b) Abb. 8: Verhältnis zwischen der effektiven Temperatur jede Bondstelle und die Bondstelle mit der höchsten Temperatur (Bond11nach [7]) in Korrelation mit den Verhältnissen der verbleibenden Scherfestigkeit und der verbleibenden Bondfläche zu den jeweiligen ursprünglichen Werten nach dem PC-Test bis 50 % von LOI (a), Risswachstumskurven dargestellt als die Verhältnisse zwischen den verbleibenden Bondflächen und den Zyklenzahlen nach dem PC-Test (b)](/images/stories/Abo-2023-10/plus-2023-10-073.jpg) Abb. 8: Verhältnis zwischen der effektiven Temperatur jede Bondstelle und die Bondstelle mit der höchsten Temperatur (Bond11nach [7]) in Korrelation mit den Verhältnissen der verbleibenden Scherfestigkeit und der verbleibenden Bondfläche zu den jeweiligen ursprünglichen Werten nach dem PC-Test bis 50 % von LOI (a), Risswachstumskurven dargestellt als die Verhältnisse zwischen den verbleibenden Bondflächen und den Zyklenzahlen nach dem PC-Test (b)
Abb. 8: Verhältnis zwischen der effektiven Temperatur jede Bondstelle und die Bondstelle mit der höchsten Temperatur (Bond11nach [7]) in Korrelation mit den Verhältnissen der verbleibenden Scherfestigkeit und der verbleibenden Bondfläche zu den jeweiligen ursprünglichen Werten nach dem PC-Test bis 50 % von LOI (a), Risswachstumskurven dargestellt als die Verhältnisse zwischen den verbleibenden Bondflächen und den Zyklenzahlen nach dem PC-Test (b)
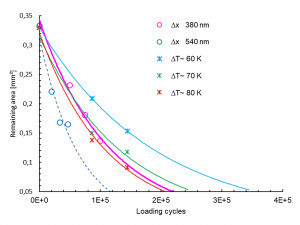 Abb. 9. Risswachstumskurven für PC und BAMFIT Tests dargestellt als Verhältnis zwischen der verbleibenden Verbindungsfläche (mm²) und den Belastungszyklen bei einem effektiven ΔT-Bereich von ~ 60, 70 und 80 K und Δx-Bereich von 380 nm bis 540 nmAnhand der verbleibenden Bondfläche in Abhängigkeit von der Zyklenzahl ergibt sich durch die Überlagerung der ermittelten PC- und BAMFIT- Risswachstumskurven eine Korrelation der beiden Prüfmethoden (Abb. 9). Unter den gegebenen Versuchsbedingungen zeigt das so gewonnene Diagramm, dass eine Verschiebungsamplitude von 380nm der BAMFIT-Methode zu einer Schädigung der Bondfläche die mit etwa 75 K im PC-Test vergleichbar ist.
Abb. 9. Risswachstumskurven für PC und BAMFIT Tests dargestellt als Verhältnis zwischen der verbleibenden Verbindungsfläche (mm²) und den Belastungszyklen bei einem effektiven ΔT-Bereich von ~ 60, 70 und 80 K und Δx-Bereich von 380 nm bis 540 nmAnhand der verbleibenden Bondfläche in Abhängigkeit von der Zyklenzahl ergibt sich durch die Überlagerung der ermittelten PC- und BAMFIT- Risswachstumskurven eine Korrelation der beiden Prüfmethoden (Abb. 9). Unter den gegebenen Versuchsbedingungen zeigt das so gewonnene Diagramm, dass eine Verschiebungsamplitude von 380nm der BAMFIT-Methode zu einer Schädigung der Bondfläche die mit etwa 75 K im PC-Test vergleichbar ist.
Die vereinfachten FEM-Simulationen bieten einen guten Richtwert für den Vergleich der Testmethoden innerhalb der Schwankungsbreite der ΔTJ-Werte der PC-Tests. Um einen genaueren Abgleich der thermisch- und mechanischen Grenzflächenspannungen zu berechnen sind ausführlichere Simulationen der BAMFIT und PC-Tests nötig. Während beim BAMFIT Test die Verschiebungsamplituden genau definiert sind, muss für eine bessere Vergleichbarkeit die experimentelle Umsetzung der PC-Tests dahingehend adaptiert werden, dass die einzelnen Bonddrähte des IGBTs ebenfalls einer entsprechenden gleichmäßigen thermischen Belastung ausgesetzt sind. So könnten zum Beispiel einzelne Drahtbonds einer geeigneten IGBT-Teststruktur geprüft werden.
Zusammenfassend ermöglicht die vorgestellte Methode einen praktischen und direkten Vergleich der durch den Risswachstum an der Draht-Metallisierungsgrenzfläche (Degradation) von Drahtbonds nach aktiven thermischen Zyklen und hoch beschleunigten mechanischen Tests. Die Möglichkeit der schnellen Bestimmung der verbleibenden Lebensdauer von Drahtbindungen als Schwachstellen von Halbleitermodulen kann wesentlich dazu beitragen, realistischere Lebensdauervorhersagen auf effiziente Art und Weise zu erstellen.
Zusammenfassung
Der Artikel gibt einen kurzen Überblick über die vielfältigen Einsatzmöglichkeiten des BAMFIT-Testers als äußerst effektives Werkzeug zur Bewertung von elektronischen Verbindungen. Neben den Beispielen von bereits bekannten Anwendungen in F&E wurde der Schädigungsgrad von Al-Drahtbonds in kommerziellen IGBT-Modulen in verschiedenen Lebensdauerintervallen nach der BAMFIT-Methode und Power Cycling Tests bestimmt und korreliert. Die so ermittelten Risswachstumskurven können zur Lebensdauermodellierung und zur Erstellung zuverlässiger Lebensdauervorhersagen mit geringem Kosten- und Zeitaufwand verwendet werden. Die vorgestellten Forschungsarbeiten wurden im ‚Christian Doppler Labor für Lebensdauer und Zuverlässigkeit von Grenzflächen in der Elektronik' an der TU Wien in Kooperation mit F&S Bondtec und Infineon durchgeführt. Die experimentelle Umsetzung der PC- Tests erfolgte durch die Gruppe von F. Iannuzzo an der Aalborg University.
Literatur
[1] M. Ohring; L. Kasprzak: Reliability and Failure of Electronic Materials and Devices, 2nd ed. Academic Press, 2011
[2] J. Lutz; H. Schlangenotto; U. Scheuermann; R. De Doncker: Semiconductor power devices, Physics, characteristics, reliability, 2, 2011
[3] Luhong Xie et al.: State-of-the-art of the bond wire failure mechanism and power cycling lifetime in power electronics, Microelectron. Reliab., vol. 147, August 2023, 115060
[4] L. Wang; W. Wang; R.J.E. Hueting; G. Rietveld; J.A. Ferreira: Review of Topside Interconnections for Wide Bandgap Power Semiconductor Packaging, in IEEE Transactions on Power Electronics, vol. 38, no. 1, S. 472-490, Jan. 2023, doi: 10.1109/TPEL.2022.3200469
[5] K. Nwanoro, H. Lu, C. Yin and C. Bailey, „Advantages of the extended finite element method for the analysis of crack propagation in power modules”, Power Electronic Devices and Components 4 (2023) 100027
[6] A. Halouani et al.: New model of crack propagation of aluminium wire bonds in IGBT power modules under low temperature variations, Microelectron. Reliab., vol. 147, August 2023, 115060
[7] H. Keting, et al.: Cost-effective prognostics of IGBT bond wires with consideration of temperature swing, IEEE Trans. Power Electron. 35 (7) (2019) 6773–6784
[8] J. Grams; A. Hofer; S. Middendorf; O. Schmitz; Wittler; K.D. Lang: A geometry-independent lifetime modelling method for aluminum heavy wire bond joints“, EuroSimE 2015, doi:10.1109/EuroSimE.2015.7103091
[9] DE102016107028A1 Bondstellen-Prüfanordnung und Bondstellen-Prüfverfahren
[10] B. Czerny; G. Khatibi: Interface reliability and lifetime prediction of heavy aluminum wire bonds, Microelectron. Reliab., vol. 58, 2016, doi: 10.1016/j.microrel.2015.11.028
[11] B. Czerny; G. Khatibi: Highly Accelerated Mechanical Lifetime Testing for Wire Bonds in Power Electronics, Journal of Microelectronics and Electronic Packaging,19, (2022), S. 49–55
[12] https://www.fsbondtec.at/portfolio/bamfit-tester/ (Abruf: 19.09.2023).
[13] B. Czerny; G. Khatibi: Cyclic robustness of heavy wire bonds: Al, AlMg, Cu and CucorAl, Microelectron. Reliab., vol. 88–90, no. July, pp. 745–751, 2018, doi: 10.1016/j.microrel.2018.07.003
[14] B. Czerny; G. Khatibi: Interface characterization of Cu-Cu ball bonds by a fast shear fatigue method, Microelectron. Reliab., vol. 114, no. May, p. 113831, 2020, doi: 10.1016/j.microrel.2020.113831
[15] V. N. Popok et al.: Comparative study of wire bond degradation under power and mechanical accelerated tests, J. Mater. Sci. Mater. Electron., vol. 30, no. 18, 2019, doi: 10.1007/s10854-019-02050-0
[16] H.-G. Von Ribbeck; T. Döhler; B. Czerny; G. Khatibi; U. Geißler, Loop formation effects on the lifetime of wire bonds for power electronics, CIPS 2020, S. 467–472, 2020
[17] G. Khatibi; B. Czerny, Internal report 2022
[18] He Du; B. Czerny; F. Iannuzzo; G. Khatibi, Internal report 2021
[19] O. Schilling; M. Schäfer; K. Mainka; M. Thoben; F. Sauerland: Power cycling testing and FE modelling focussed on Al wire bond fatigue in high power IGBT modules, Microelectronics Reliability 52 (2012)
[20] K.-D. Lang; J. Goehre; M. Schneider-Ramelow: Interface Investigations and Modeling of Heavy Wire Bonds on Power Semiconductors for End-of-Life Determination, Electronics Packaging Technology Conference, 2008
[21] N. Jiang; M. Kalajica; J. Lutz: On-time Dependency on the Power Cycling Capability of Al Bond Wires Measured by Shear Test, CIPS 2018 – 10th International Conference on Integrated Power Electronics Systems
[22] J. Onuki; M. Koizumi; M. Suwa: Reliability of thick Al wire bonds in IGBT modules for traction motor drives, IEEE Trans Adv Packag 23 (1), 2000, S. 108–112












